SMT CPU socket功能测试不良经典案例:从问题根源到解决方案
此案例在SMT工艺分析中有一定的参考作用,因此今天特意总结分享给大家,具体说明如下:
一、问题描述
-
物料信息: Lotes 品牌的CPU socket,如下图所示:
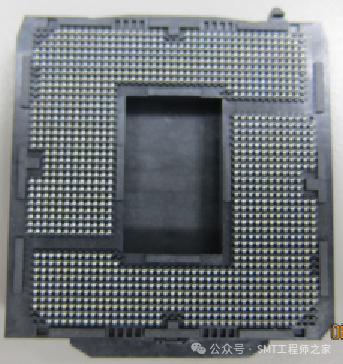
-
生产信息: 经过调查此零件在多个产品上都有使用,收集信息发现此零件在每个产品都有一定的不良率,不良率平均在2%左右,不良现象为功能测试Open;
二、 问题分析:
-
外观检查: 从外观检查未发现接触Pin变形等不良,同时使用侧镜检查外排锡球与PCB pad之间焊接良好,无焊点偏移与拒焊现象;
-
X-ray检查:
将X-ray的照射角度调整到53°时发现如下现象:
1)不良讯号点位的锡球与金针明显脱离开,该现象为此功能Open的原因. 2)再取不良板确认, 不良焊点位置都发现锡球与金针脱开现象;
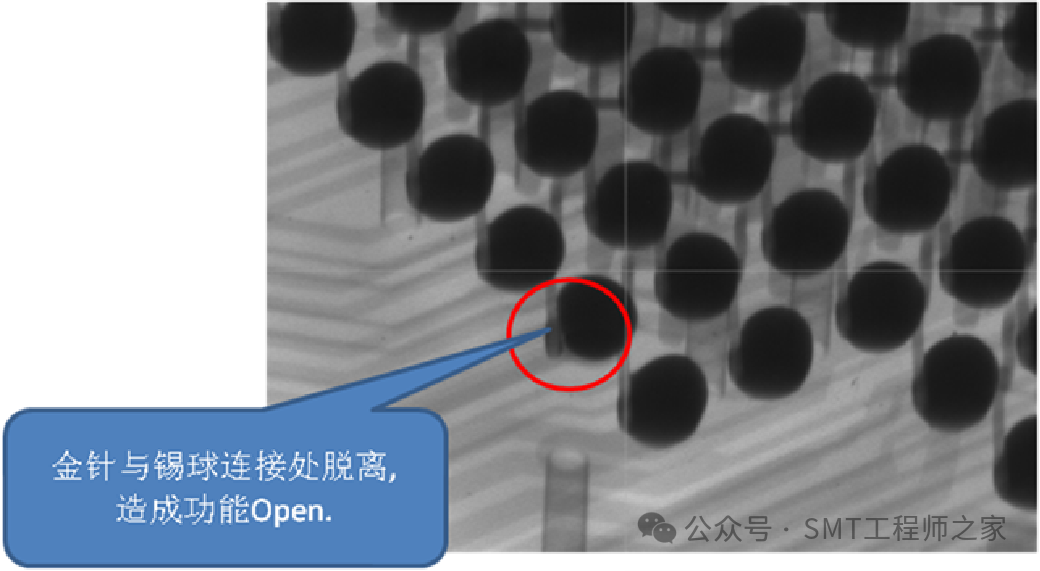
-
CPU socket 锡球与金针脱离原因分析之生产过程调查: 1)不良点位分析: 针对所有不良品进行不良位置统计分析,发现不良点不集中,边角、中间都有不良,因此排除边角由于应力导致锡裂的可能; 2)从X-ray检查: 其结果来看锡球及锡膏与PCB pad之间有形成良好焊接,初步排除锡量不足问题,但是上级需要有更进一步的证据说明,因此调查了印刷锡膏量,发现锡膏印刷也无异常:钢网开孔为1:1.1开孔,同时SPI检测记录无异常;

3)Reflow焊接条件调查: 通过对比调查Profile实测结果满足零件规格书要求的Profile参数,同时回焊炉的实时温度检测也无异常;

-
物料D/C调查 发现物料D/C集中在同一个D/C, 进一步说明此不良与CPU socket物料关系密切; -
切片分析: 由于需要与物料厂商做进一步分析澄清原因,因此,我们进行了切片分析,经过切片分析发现如下明显的异常 NG板做切片分析,切片结果如下: 1)金针与锡球脱离; 2)锡球与PCB焊锡未焊接(可能是金针顶触到PCB造成锡球不共面); 3)金针顶到PCB板绿漆层;
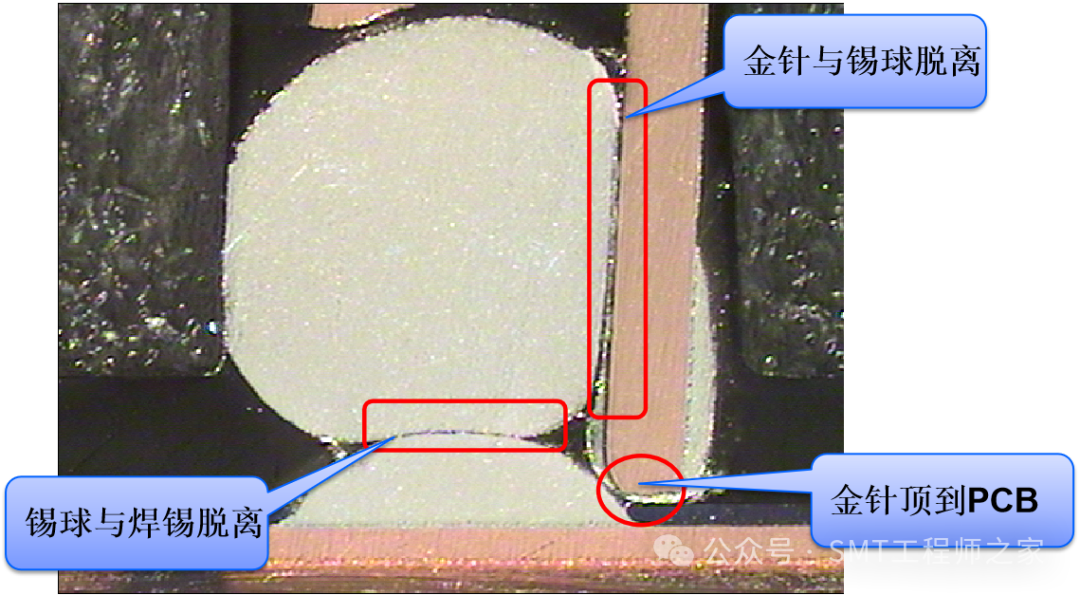
4)比较同排的板边锡球的焊接外观发现差异明显:
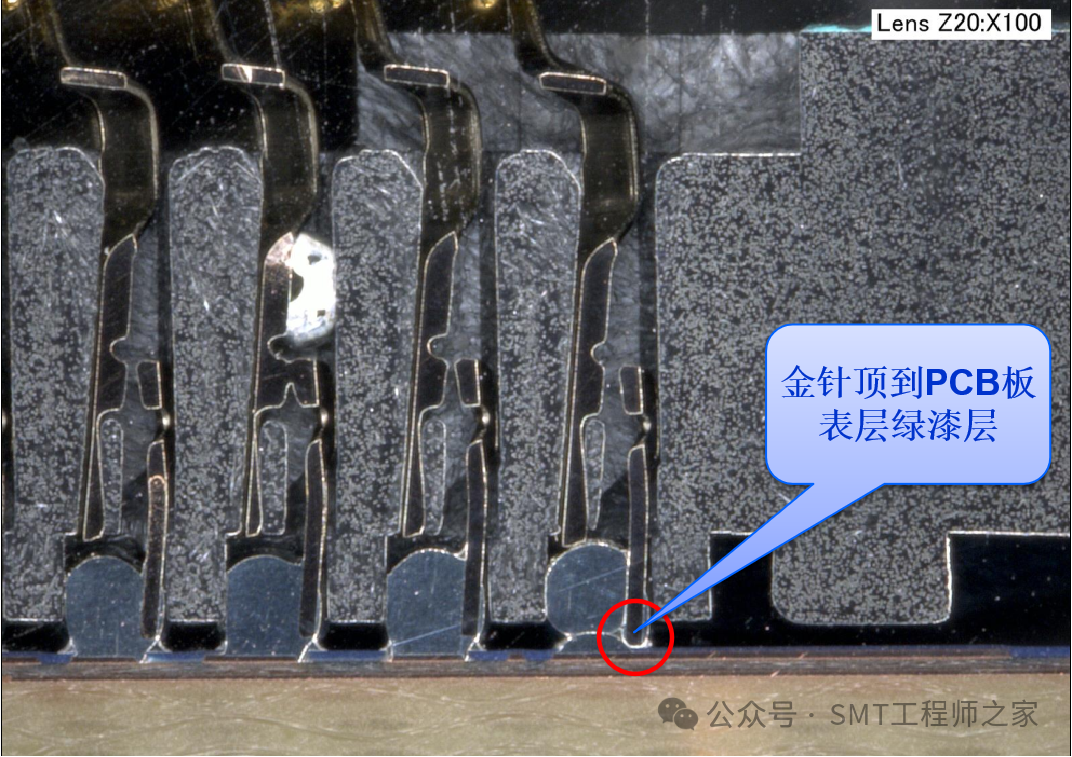
5)量测同排的板边锡球的焊接状况发现差异明显:
NG 焊点的金针距离表层焊盘距离为1.484 mil; OK 焊点的金针距离表层焊盘距离为3.992mil;
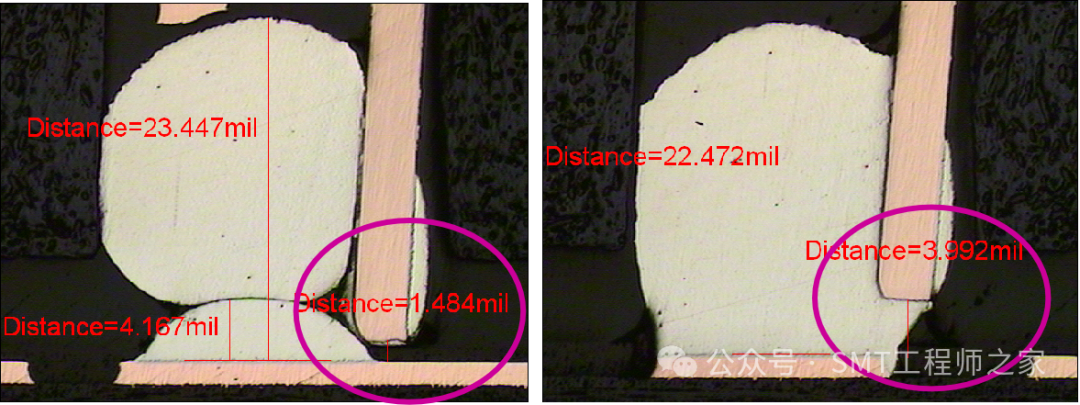
-
分析总结:
金针顶触到PCB板,且金针与锡球脱落, 确定该Issue 是物料问题造成;
三、改善对策:
后续通过与供应商共同改善物料,使用新D/C物料生产2,0000pcs未再发现异常;
以上实际不良例案,如果大家觉得有用,请大家帮忙点关注,并转发给有更多有需要的人,让大家平时分析少走弯路;
本站所有转载文章系出于传递更多信息之目的,且明确注明来源,不希望被转载的媒体或个人可与我们联系,我们将立即进行删除处理。