在电子制造领域,SMT(表面贴装技术)以其高精度、高效率的特点,成为了现代电子产品制造的主流技术。然而,随着技术的不断进步和产品的日益复杂化,SMT制造过程中也面临着诸多挑战,其中之一便是BGA(球栅阵列)封装器件的空焊问题。空焊不仅会影响产品的性能和可靠性,还可能导致产品失效,给制造商带来经济损失。因此,对SMT BGA空焊问题进行深入研究,找出其形成原因并提出有效的解决方法,对于提高电子产品的质量和可靠性具有重要意义。
本文将首先介绍SMT BGA空焊的定义和形成原因,然后详细分析可能导致空焊的各种因素,最后提出针对性的解决方法和预防措施。希望通过本文的探讨,能为电子制造领域的同行提供一些有益的参考和启示。
一、SMT BGA空焊定义
SMT BGA空焊是指BGA封装器件的锡球未能与PCB(印刷电路板)上的焊盘形成有效连接,即焊点应焊而未焊的现象。
二、SMT BGA空焊形成原因


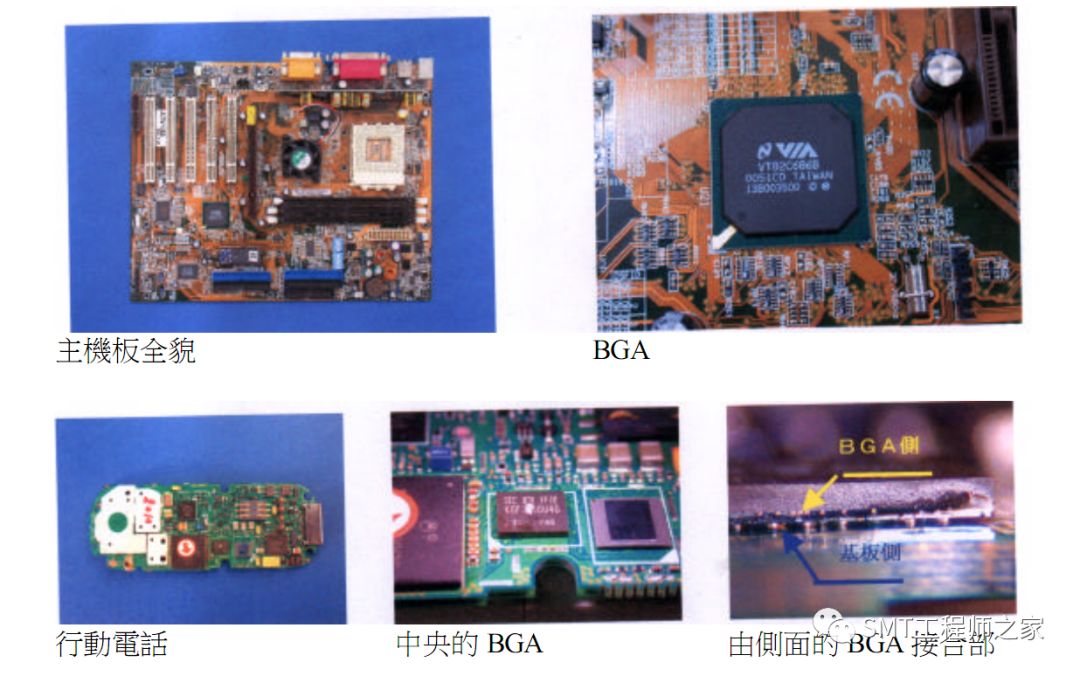
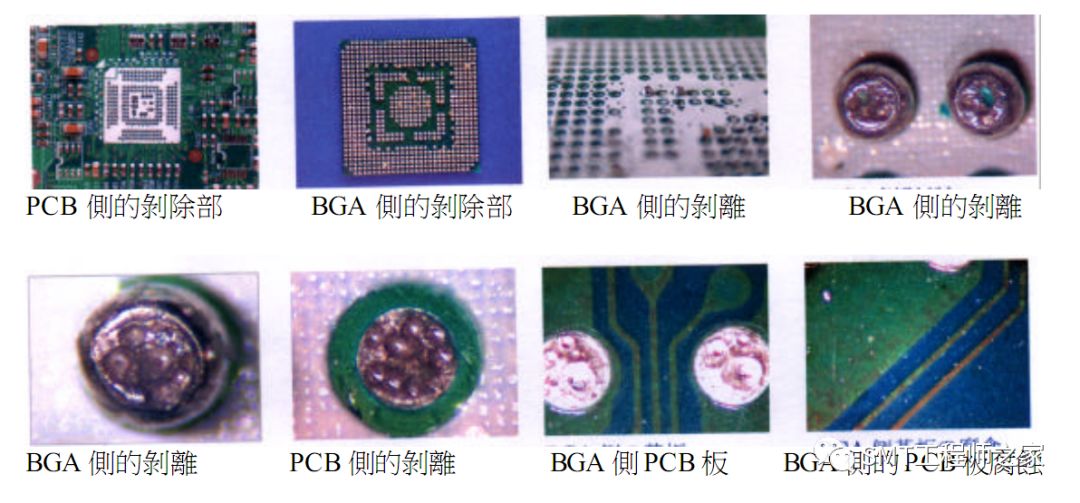


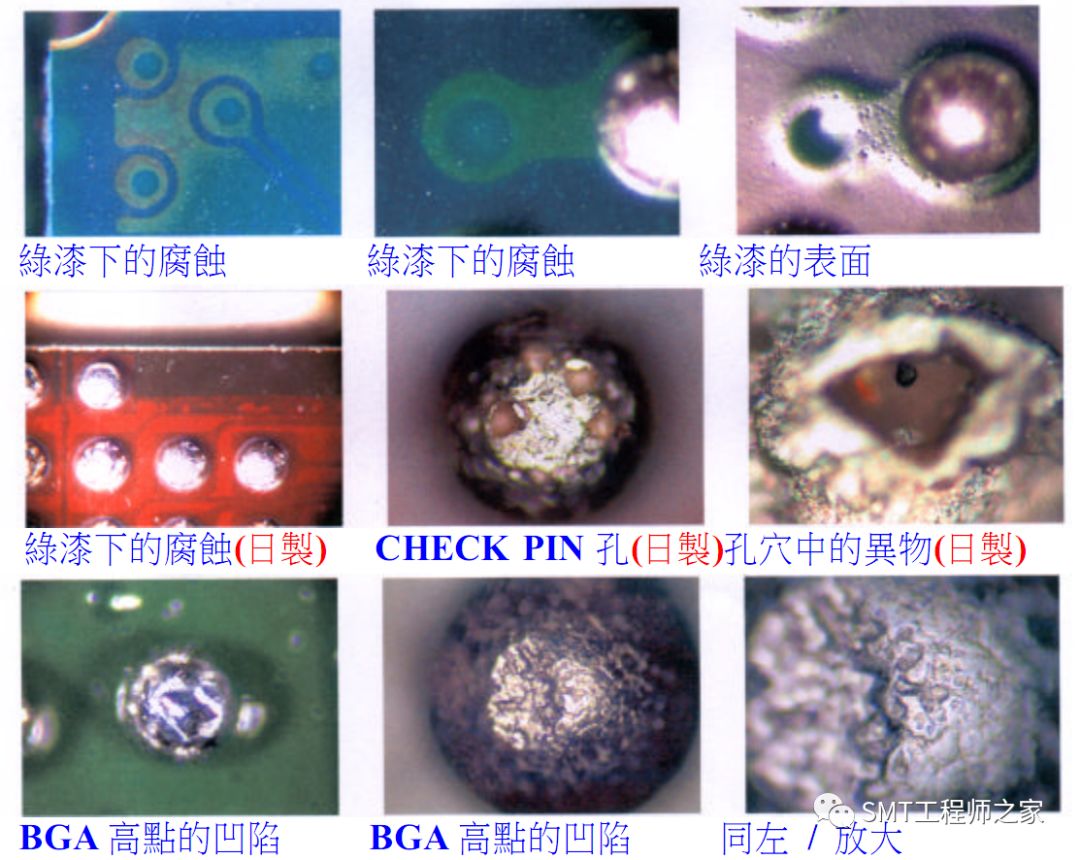
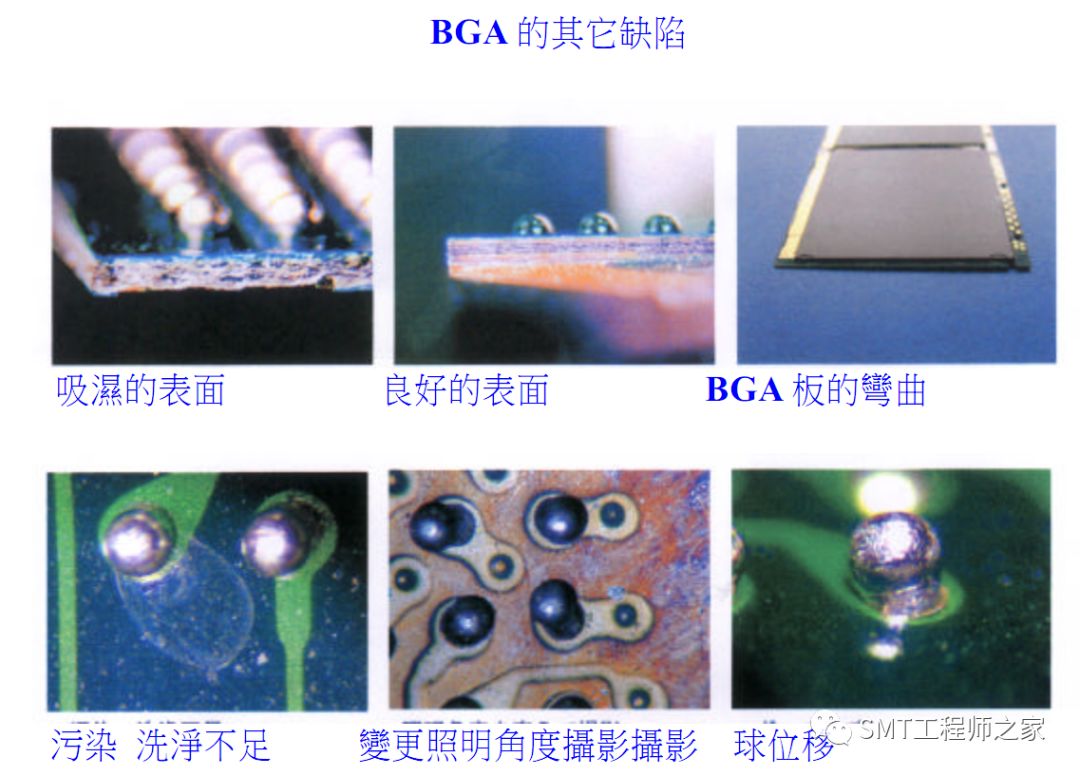

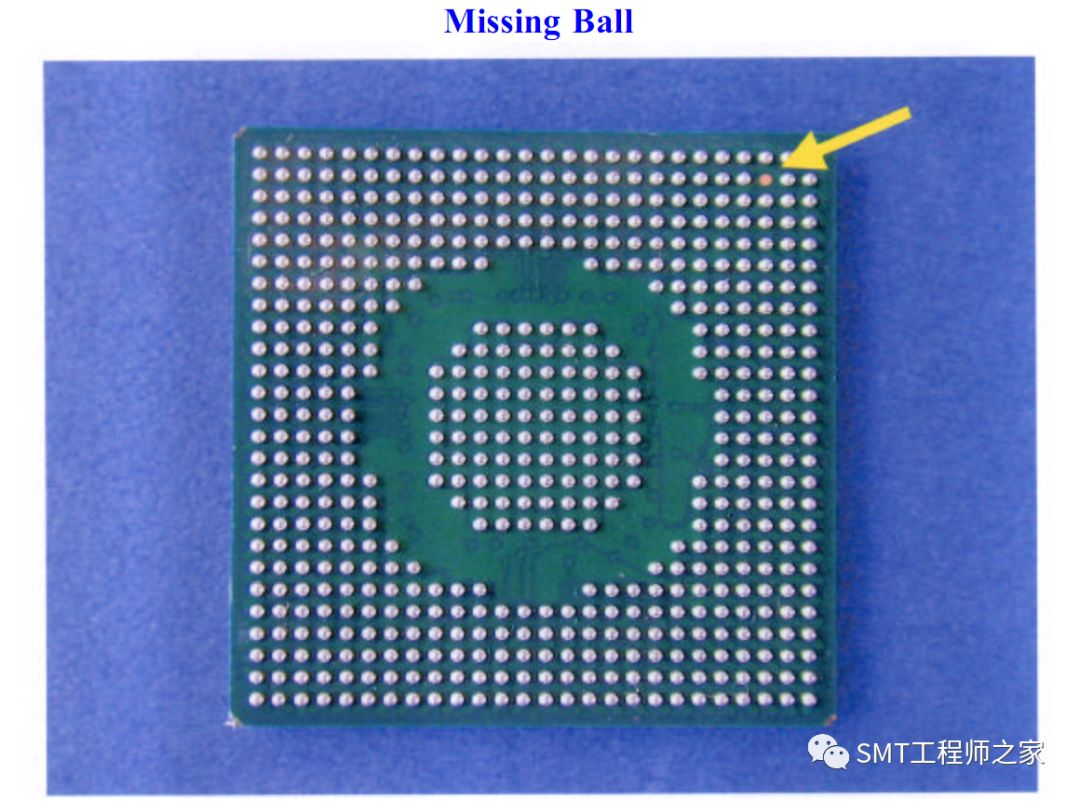
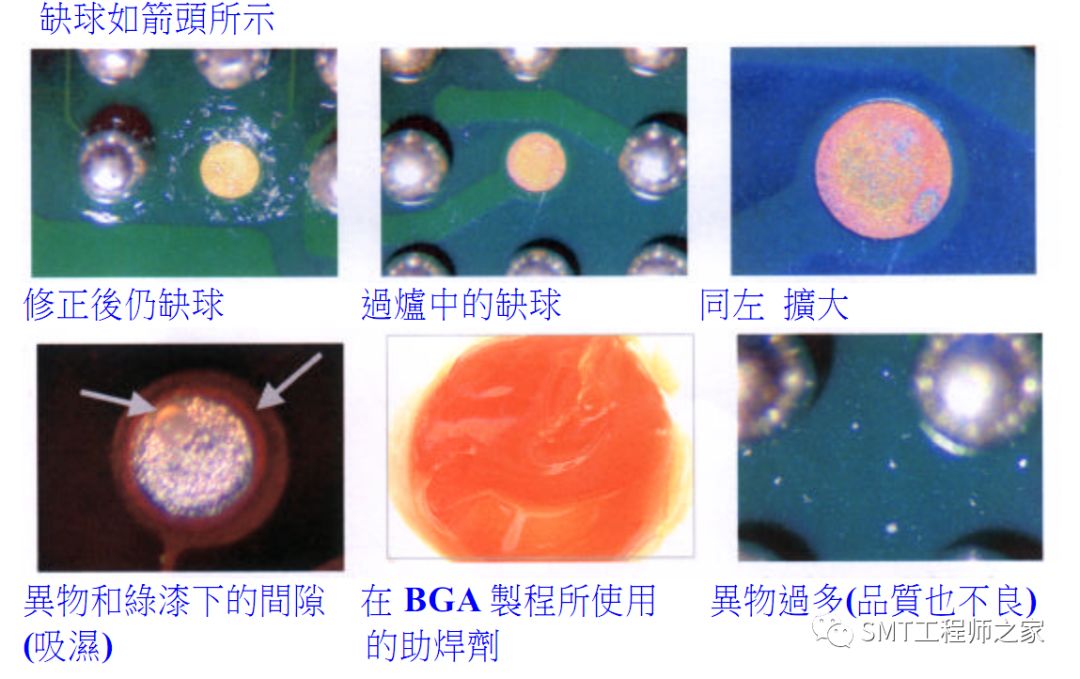
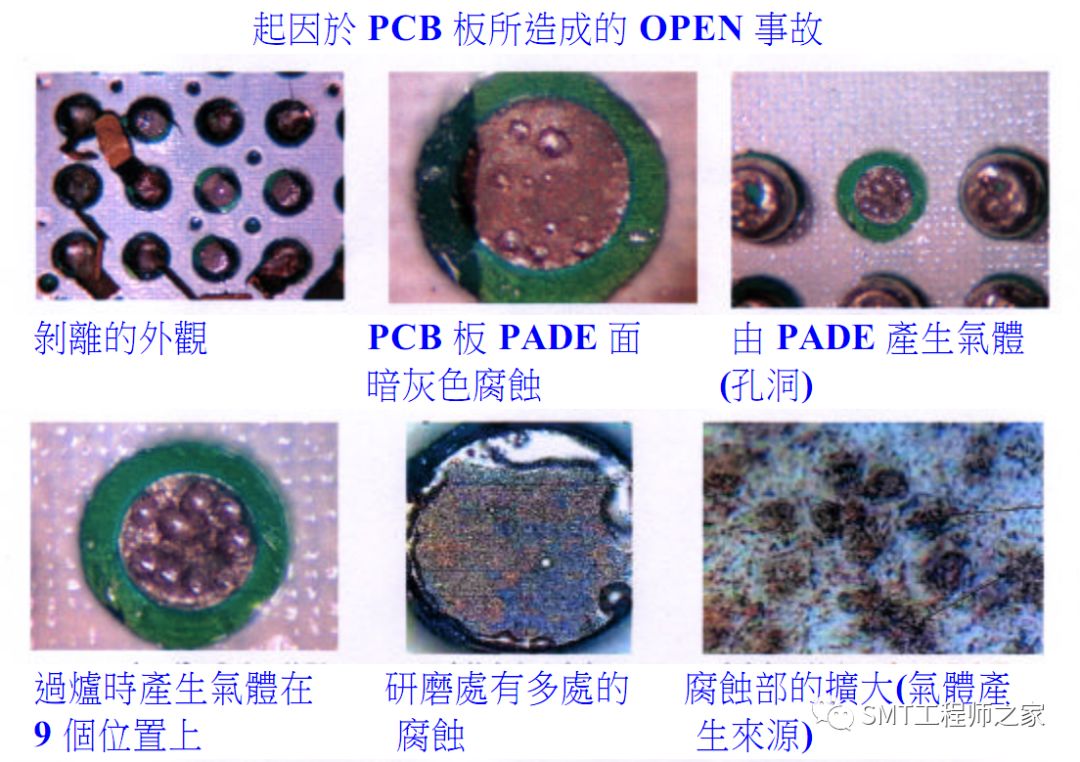
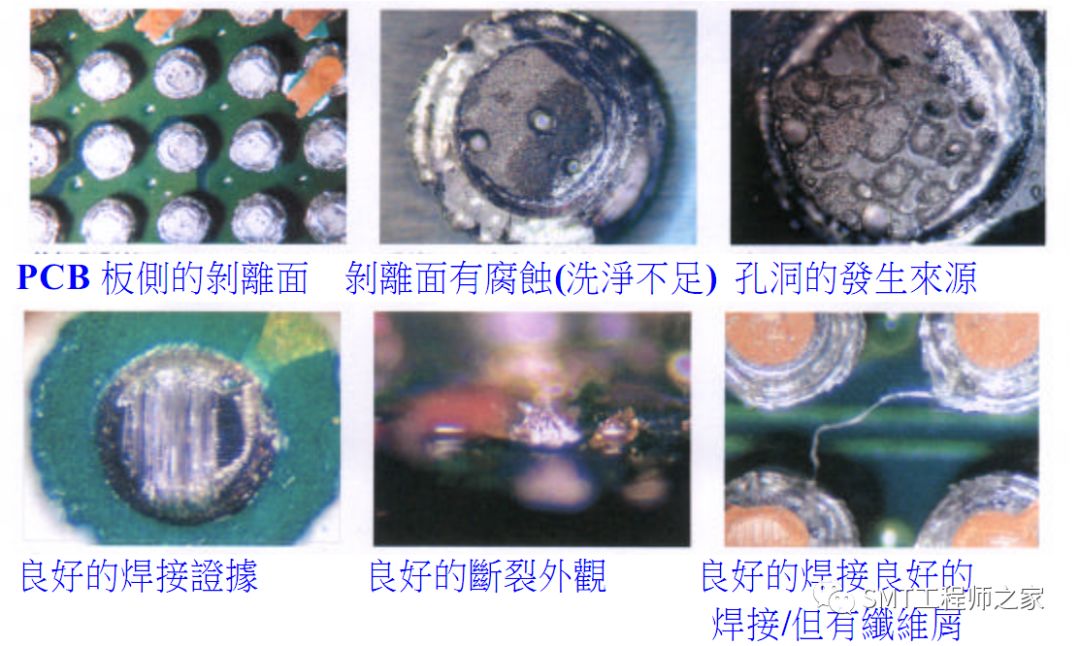
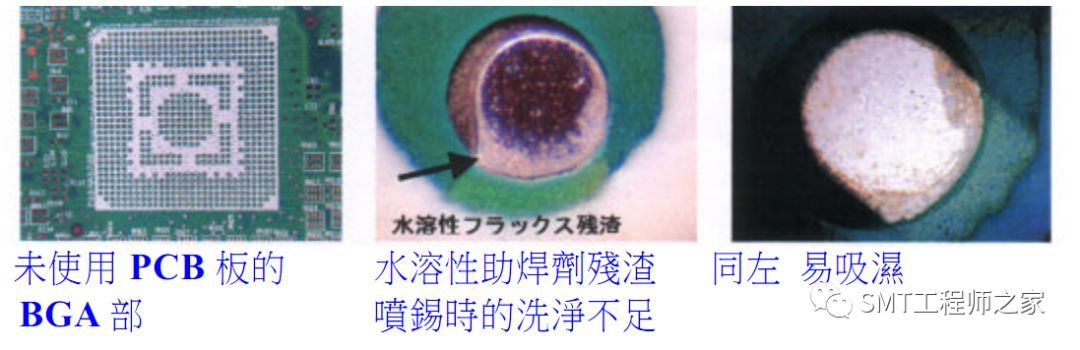
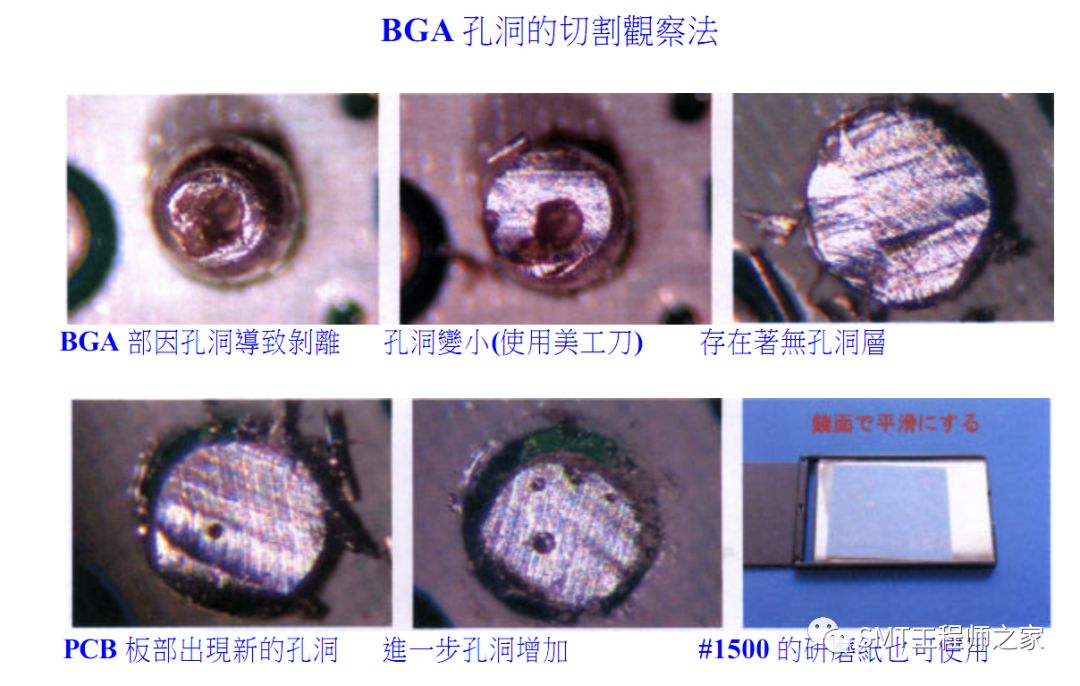
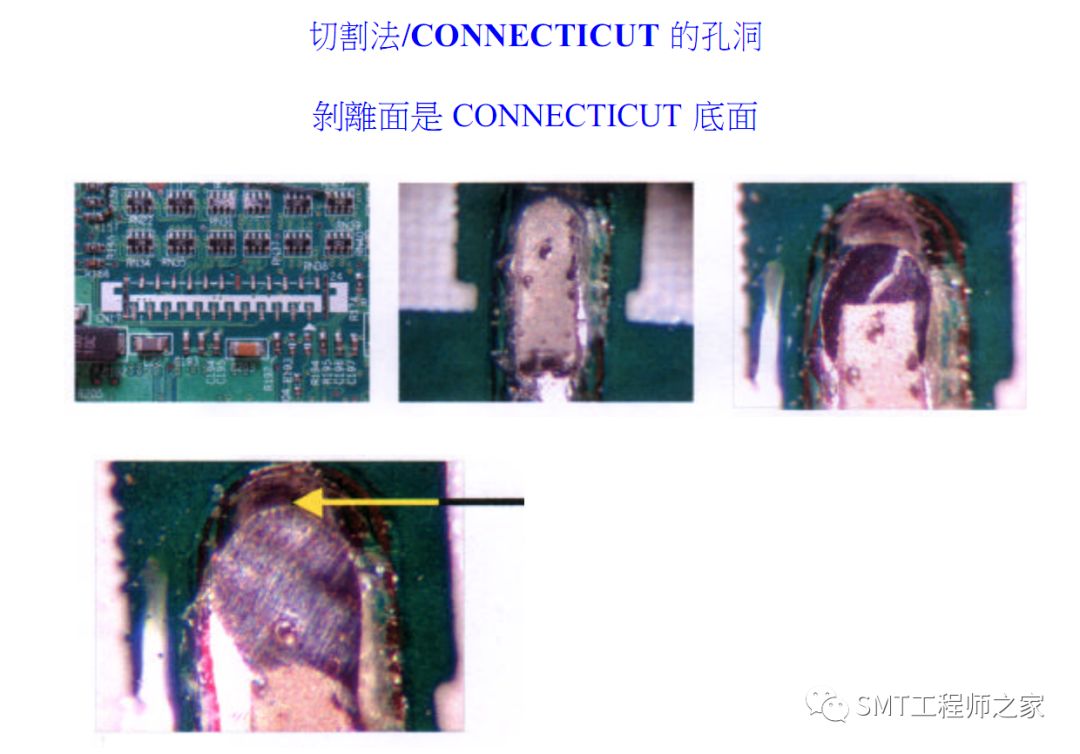
三、SMT BGA空焊解决方法
针对SMT BGA空焊问题,解决方法有如下几点参观:
1、优化炉温曲线
1) 升温段控制:
确保温度变化率适中,避免快速升温导致的气体快速逸出对BGA造成影响。
升温段的持续时间应足够长,确保本应挥发的气体能够完全逸出,避免在回流阶段继续逸出影响焊接。
2) 恒温区调整:
减少恒温区时间,避免助焊剂在此区域挥发过多,造成回焊区无助焊剂可焊。
尽量做线性升温RTS(Rise Time Setpoint),以减少助焊剂在恒温区的损失。
2、助焊膏管理
1) 选用合适的助焊膏:
确保助焊膏对焊盘的润湿能力足够,能够有效去除焊盘上的氧化层,避免虚焊。
选择具有低软化点的松香,对于BGA助焊膏来说尤为重要。
2) 控制助焊膏的沉积量:
沉积量过少可能导致焊点无法充分形成,沉积量过多则可能引入杂质或气泡。
定期检查并调整助焊膏的喷涂参数,确保沉积量在合理范围内。
3、回流焊工艺优化
1) 氮气保护:
在有条件的情况下,使用氮气保护可以隔绝氧气,避免焊料和元件脚氧化,提高焊接质量。
2) 钢网修改:
对于0.4mm Pitch的BGA PCB PAD,可以将原本1:1的开孔修改为0.24mm方形,以增加下锡量,提高焊接可靠性。
4、PCB板与BGA封装检查
1) PCB板设计检查:
确保焊盘设计合理,间距适当,避免锡流入过孔等问题。
检查PCB板是否存在制造过程中的缺陷,如脱裂、缝隙等。
2) BGA封装检查:
在组装前检查BGA封装的焊球是否存在缺陷或夹杂的空洞。
确保BGA封装过程中焊球的位置正确,避免偏移或倾斜。
5、检测与预防
1) 使用检测设备:
采用X射线检测设备对BGA封装的焊接质量进行检查,及时发现空焊问题。
2) 预防措施:
定期对SMT生产线进行维护和保养,确保设备处于良好状态。
加强员工培训,提高操作技能和质量意识。
严格控制原材料的质量,确保使用的焊膏、PCB板、BGA封装等符合质量要求。
通过上述方法的综合应用,可以显著降低SMT BGA空焊的发生率,提高焊接质量和产品的可靠性。









