半导体行业发展愈发成熟,企业对专利的保护意识不断增强,近日,中芯国际、长鑫存储、三安半导体、芯华章等企业新专利曝光。
中芯国际公布两项专利
中芯国际本月公布了两项新的专利,分别是“承载装置、晶圆测试设备以及晶圆测试方法”专利以及“一种晶圆测试装置”专利。
“承载装置、晶圆测试设备以及晶圆测试方法”专利公布
天眼查显示,中芯国际“承载装置、晶圆测试设备以及晶圆测试方法”专利公布,申请公布日为9月1日,申请公布号为CN116682750A。
该专利的专利权人为中芯国际集成电路制造(上海)有限公司、中芯国际集成电路制造(北京)有限公司。
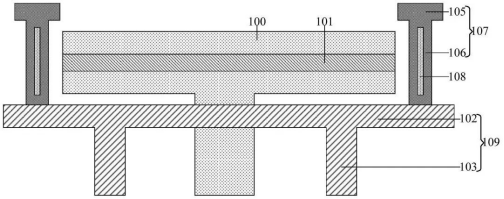
图片来源:天眼查
专利摘要显示,一种承载装置、晶圆测试设备以及晶圆测试方法,承载装置包括:主加热平台,用于承载待测晶圆并对所述待测晶圆进行加热;环形的副加热平台,环绕所述主加热平台,用于与所述主加热平台顶面围成放置所述待测晶圆的容纳空间。
降低了所述探针因受热不均匀而产生针痕偏移的风险,有利于提高晶圆测试的可靠性,并降低因晶圆表面破损而产生良率损失和可靠性风险的概率;同时,在对待测晶圆进行高温测试的过程中,由于所述探针卡上的各探针受热均匀,在测试过程中,省去了对所述探针卡进行预热的步骤,提高了生产效率,降低了测试成本。
“一种晶圆测试装置”专利获授权
天眼查显示,中芯国际集成电路制造(上海)有限公司“一种晶圆测试装置”专利获授权,授权公告日为9月15日,授权公告号为CN219695349U。
专利摘要显示,本申请提供一种晶圆测试装置,所述晶圆测试装置包括:承载台,用于承载晶圆;晶圆夹具,所述晶圆夹具的工作面与所述晶圆的边缘匹配使得所述晶圆夹具工作时所述晶圆夹具的工作面和所述晶圆的边缘贴合并且所述晶圆夹具的上表面和所述晶圆的上表面共面。本申请提供一种晶圆测试装置,利用晶圆夹具与晶圆边缘的弧形倒角贴合,避免测试探针扎在弧形倒角上弯曲,可以避免探针卡在测试过程中损坏,并提高晶圆测试效率。
三安半导体器件专利获授权
天眼查显示,湖南三安半导体有限责任公司“半导体器件”专利获授权,授权公告日为9月15日,授权公告号为CN219696448U。

图片来源:天眼查
专利摘要显示,本申请公开了一种半导体器件,属于半导体技术领域。半导体器件包括芯片;基板,基板包括安装部和第一端子,第一端子连接在安装部的第一端部;塑封体,安装部包括裸露在塑封体的顶面的第一面和被塑封体包裹的第二面,芯片安装在安装部的第二面,第一端子从塑封体的第一侧伸出并向塑封体的底面弯折;第二端子和第三端子,第二端子和第三端子与芯片电连接且从与塑封体的第一侧相对的第二侧的中部伸出;安装部还包括与第一端部相对设置的第二端部,在安装部的第二端部与第二端子和第三端子之间的塑封体上设置有凹槽,可增大基板与第二端子和第三端子之间的爬电距离,从而提高了半导体器件的安全性。
芯华章专利获授权
天眼查显示,芯华章科技股份有限公司“集成电路设计验证”专利获授权,授权公告日为9月19日,授权公告号为CN114417755B。
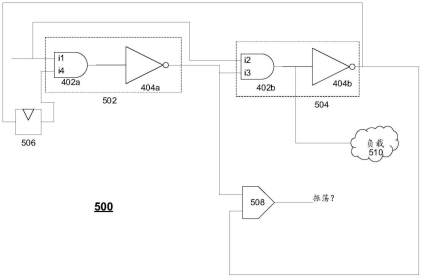
图片来源:天眼查
专利摘要显示,本申请提供用于验证IC设计(诸如超大规模集成电路(VLSI)设计)的方法和设备。该方法包括:获得IC设计的描述;基于所述描述确定所述IC设计是否包括组合回路,其中所述组合回路包括输出和连接到所述输出的输入;响应于所述IC设计包括所述组合回路,展开所述组合回路为展开回路,所述展开回路包括:连接以形成所述展开回路的第一迭代和第二迭代,其中所述第一迭代包括第一输出和第一输入,所述第二迭代包括第二输出和第二输入,并且所述第二输出连接到所述第一输入;以及连接在所述第一输入和所述第二输出之间的寄存器;以及验证具有所述展开回路的IC设计,其中所述第一迭代和所述第二迭代中的每一个包括与所述组合回路相同的组件。
长鑫存储两项专利曝光
长鑫存储两项新的专利近日也得到曝光,分别是“一种晶圆缺陷分析方法、系统、设备和介质”专利、“存储芯片的测试方法及装置”专利。
长鑫存储“一种晶圆缺陷分析方法、系统、设备和介质”专利获授权
天眼查显示,长鑫存储技术有限公司“一种晶圆缺陷分析方法、系统、设备和介质”专利获授权,授权公告日为9月15日,授权公告号为CN113837983B。

图片来源:天眼查
专利摘要显示,本发明公开了一种晶圆缺陷分析方法、系统、设备和介质。该晶圆缺陷分析方法包括获取半导体制程工艺中每片晶圆的批次信息以及缺陷信息,缺陷信息包括热点缺陷信息;设定热点缺陷特征,从热点缺陷信息中筛选出与热点缺陷特征相关联的目标热点缺陷信息;根据批次信息,追踪与热点缺陷特征相关联的目标热点缺陷信息所对应的第一片晶圆,确定缺陷源。
据悉,在本发明实施例中,通过在半导体制程工艺中获取晶圆的批次信息以及热点缺陷信息,并根据热点缺陷特征筛选出目标热点缺陷信息,最后追踪目标热点缺陷信息所对应的第一片晶圆,确定缺陷源,提高了晶圆缺陷溯源的准确性。
长鑫存储“存储芯片的测试方法及装置”专利公布
天眼查显示,长鑫存储技术有限公司“存储芯片的测试方法及装置”专利公布,申请公布日为9月15日,申请公布号为CN116758970A。

图片来源:天眼查
专利摘要显示,本公开提出一种存储芯片的测试方法及装置,适用于存储技术领域,可以解决,能够解决人工方式生成随机测试向量难以保证随机性和覆盖率,且容易发生错误的问题,可以提高存储芯片的测试效率。该方案包括:根据存储芯片的标准状态机,获取存储芯片的简化状态机,简化状态机用于描述存储芯片的主要功能;确定简化状态机中的状态跳转的重要性的指示信息;基于简化状态机的状态跳转的重要性的指示信息,生成存储芯片的测试向量。
封面图片来源:拍信网
