
版权声明:本文内容来自互联网,如您觉得不合适,请与我们联系,谢谢。
如果历史可以重演的话,日本人Takanashi一定会重新选择申请专利的时间。1984年,正是他在一项美国专利中定义了浸入式光刻机最基本的结构特征,即在最后一级物镜与光刻胶之间充入一层透明的液体。只可惜这项专利诞生的“过早”,真正意义上的浸入式光刻要在若干年后才会出现,Takanashi也因此与巨额专利费擦肩而过。
然而历史的发展就是这样奇妙,一个当时甚为大胆的想法在日后也许就会风光无限。浸入式光刻从最初的想法雏形到现如今推动摩尔定律继续前进,其间经历波折无数,未来也注定不会是平坦大道。它的魅力究竟在哪里,未来又会有哪些发展趋势呢?就让我们带着对浸入式光刻的疑问一探究竟吧。
为什么是浸入式光刻?
自从摩尔定律被提出,人类的想象力就得到了无限发挥的空间。每一次尺寸缩小就意味着制程上的革新,一幕幕工艺上的改朝换代就这样不断上演,浸入式光刻也就此走上了历史舞台。
浸入式光刻的原型实验在上世纪90年代开始陆续出现。1999年,IBM的Hoffnagle使用257nm干涉系统制作出周期为89nm的密集图形。当时使用的浸入液是环辛烷。但因为当时对浸入液的充入、镜头的沾污、光刻胶的稳定性和气泡的伤害等关键问题缺乏了解,人们并未对浸入式光刻展开深入的研究。
2002年以前,业界普遍认为193nm光刻无法延伸到65nm技术节点,而157nm将成为主流技术。然而,157nm光刻技术遭遇到了来自光刻机透镜的巨大挑战。这是由于绝大多数材料会强烈地吸收157nm的光波,只有CaF2勉强可以使用。但研磨得到的CaF2镜头缺陷率和像差很难控制,并且价格相当昂贵。雪上加霜的是它的使用寿命也极短,频繁更换镜头让芯片制造业无法容忍。
正当众多研究者在157nm浸入式光刻面前踌躇不前时,时任TSMC资深处长的林本坚提出了193nm浸入式光刻的概念。在157nm波长下水是不透明的液体,但是对于193nm的波长则是几乎完全透明的。并且水在193nm的折射率高达1.44,而可见光只有1.33!如果把水这样一种相当理想的浸入液,配合已经十分成熟的193nm光刻设备,那么设备厂商只需做较小的改进,重点解决与水浸入有关的问题,193nm水浸式光刻机就近在咫尺了。同时,193nm光波在水中的等效波长缩短为134nm,足可超越157nm的极限。193nm浸入式光刻的研究随即成为光刻界追逐的焦点。
浸入式光刻是指在光刻机投影镜头与半导体硅片之间用一种液体充满,从而获得更好分辩率及增大镜头的数值孔径,进而实现更小曝光尺寸的一种新型光刻技术(下图)。
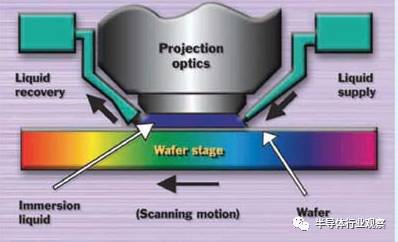
浸入式光刻示意图
让我们看一下光刻系统分辨率的著名Rayleigh方程:
R=kλ/NA
式中λ是光的波长,NA是系统中透镜的数值孔径,k是分辨率系数,代表了所有的其它工艺变量。显而易见,减小曝光光源的波长并增加投影透镜的NA都可以提高分辨率。自从193nm波长成为主攻方向以后,增大NA成为了业界人士孜孜不倦的追求。表1是提高193nm ArF浸入式光刻机NA的方案。由此可见,浸入液、光刻设备和其它相关环节的紧密配合是浸入式光刻技术前进的保证。
谁是水以后的接班者?
将液体置于主镜头和硅片之间,入射光线自然而然地就会穿透比空气折射率更高的液体,这种方式本身并没有提高特定投影图像的分辨率,但是它却能够赋予光刻机的镜头更高的数值孔径。
NA=n sinα,其中n是透镜周围介质的折射系数,α是透镜的接受角。传统的“干法”光刻系统中,介质是折射系数为1的空气,则NA的理论最大值为1。采用具有更高折射系数的液体,浸入技术有可能使系统的NA>1。比如使用折射率为1.44的去离子水后,NA的理论最大值即为1.44。在193nm曝光系统中,分辨率R=kλ/NA就可以达到k*193/1.44=132mn。如果液体不是水而其它液体,但折射率比1.44高时,则实际分辨率可以非常方便地再次提高,也这是浸入式光刻技术能很快普及的原因。Nikon上海的技术部副总经理田晓明介绍说,水作为浸入液的一大优势是它与193nm光刻胶的反应很小,并且可以通过光刻胶的改进或是增加顶部覆盖层来降低水的影响。这也是水能够被广泛应用的原因之一。
浸入式光刻的数值孔径大小是与使用液体的折射率是直接相关的。因此,人们正在着眼于寻找除水以外具有更大折射率的液体。早在2005年SPIE Microlithography的年会上,JSR和DuPont等公司就已经公布了它们的高折射率液体的研发计划。在选择高折射率液体时,考虑的重点包括:与光刻胶没有反应;光透过率高;折射率高;其它各种特性良好(表2)。已研发出的第二代浸入液的折射率为1.64,该液体氧气的吸收很少,即便被曝露于空气中性能也十分稳定。并且由于蒸汽压很低,所以很难发生热分解。这个折射率数值能够把193nm光刻机的有效波长降低到大约116nm左右。至于第三代浸入液,它的折射率应为1.8左右,同时还需要有更高折射率的镜头才能达到约1.65的NA值。
浸入液体在未来仍有许多问题亟待解决:什么样的液体更适合浸入式光刻的需求;液体的供给与回收;液体传输中的流速、气泡、温度、压力的控制;液体特性,例如流速、气泡、温度、压力变化对光学性能(折射率,吸收,散射、双折射、像差)的影响及其测量与控制;偏振光照明时,液体与抗蚀剂的相互作用;液体折射率与液体两侧元件折射率匹配;液体与光刻环境中相关元件的兼容性等。
光刻设备如何齐头并进?
在光刻设备领域,一直是ASML、Nikon和Canon的“三国演义”,浸入式光刻系统自然也是各有千秋。
Nikon专有的局部填充技术(Local Fill Technology)能够消除扫描导致的浸没缺陷、气泡、水印或晶圆背部玷污。该项技术还能消除浸入液体的蒸发,从而有利于防止由浸液导致的套准问题。Nikon的浸入式光刻设备主要面向45nm量产工艺,也可以用于32nm工艺的研发工作。
荷兰光刻巨头ASML的Twinscan NXT系列浸入式光刻系统则是针对38nm存储器和32nm逻辑芯片产品的大规模量产化制造,该系统采用1.35NA的镜头和新型的机台设计理念,将测量和曝光同时进行,得以在第一时间得到结果反馈,不仅套刻精度、分辨率得到很大提高,而且生产能力也提升了30%以上。“对于代工厂来说,在关心最终良率的同时,如何大幅提高生产能力是提高竞争能力的关键,”ASML负责亚洲事务的市场主管Ryan Young说,“创新的光刻系统设计有助于光刻工艺引领摩尔定律向前发展。
对于光刻设备来说,镜头是制约发展的主要瓶颈之一。通过改善光学主镜头来提高光刻机NA的主要途径有两个:一是用弯曲主镜头替代平面镜头。但弯曲主镜头的表面很难控制浸入液体的流动,用于浸入式光刻机有一定难度;二是寻找高折射率的光学主镜头材料。目前193nm ArF浸入式光刻机主镜头折射率为1.56,IBM与JSR联合推出Nemo系统主镜头采用高密度石英材料,其折射率为1.6。折射率为2.1的镥铝柘榴石(LuAG)是候选热门之一。
尽管理论上折射式镜头能够扩展到很高的NA,但是由于受到材料和光刻机尺寸的限制,这种扩展难度太大,成本过高。因此,要想研制超高NA的下一代镜头,更换思路,采用截然不同的镜头设计可能会柳暗花明。
新型的反射折射式镜头将折射透镜和反射镜结合起来,能够在保持光刻机尺寸不变的条件下使镜头更加紧凑和更易操作。另外,既使只用一种透镜材料,通过使用凹面镜和凹透镜等元件,设计得当的反射折射式镜头能够很好地对色差进行补偿。通过使色差最小化,能够抑制由激光带宽变动所引起的光学邻近效应。然而,反射折射式镜头的研制还需要克服许多设计难题,比如局部光斑、入射角和热象差、偏振状态控制能力的保持,以及多/单轴配置的选择和所用反射镜的数量与类型等镜头设计细节,都对这些挑战有重要的影响。
万物归EUV
如果光刻技术要数现代集成电路上的第二大难题,那么绝对没有别的因素敢称第一。目前,193nm 液浸式光刻系统是最为成熟的技术,它在精确度及成本上达到了一个近乎完美的平衡,短时间内很难被取代。不过,一种名为极紫外光刻(EUV 光刻)的技术半路杀出,成为近年来英特尔、台积电等芯片公司追捧的新宠。有人认为EUV 光刻能够拯救摩尔定律,但事实是否真的如此?
现在,科技的发展的确到了一个转折点。荷兰的光刻工具制造商 ASMLHolding 生产的 EUV 光源即将开始商业化投产。作为技术领航人的 ASML 公司,目前已经开始发货 EUV 光源,预计在 2018 年可实现最新的微处理器和存储器的批量生产。世界最先进的芯片制造商正在筹备将这些机器应用到自己的生产线中。
这样做的风险很高。摩尔定律正在面临巨大挑战,没有人能确定去年总产值为 3300 亿美元的半导体产业将如何引导 5 年或是 10 年内的发展,也无人知晓“后摩尔定律”时代的半导体行业未来会是什么样子,利润的下降也可能是无法避免的。但是如果摩尔定律能有效地避免半导体行业营业额下降,即使只有 15%,它的现金流仍然是整个美国游戏产业营业额的两倍。
光蚀刻系统制造的精细程度取决于很多因素。但是实现跨越性进步的有效方法是降低使用光源的波长。几十年来,光刻机厂商们就是这么做的:他们将晶圆曝光工具从人眼可见的蓝光端开始逐渐减小波长,直到光谱上的紫外线端。
但是,EUV 技术是非常困难的。在使用波长近乎为X光的射线去蚀刻时,物理学知识并不能为工程师帮上多少忙。对于公司最终选择的 13.5nm 波长射线,这种光可以轻易地被很多材料吸收。van Dijsseldonk补充道:“即使我们呼吸的空气也是完全的黑色,因为它也吸收了最后一点射线。”所以他和他的团队很早就意识到,EUV光刻机只能在真空下运行,晶圆通过一个气闸进出光刻机。
之后接踵而来的就是让射线弯曲的问题。EUV 也能被玻璃吸收,所以在机器中改变其走向,需要使用反射镜来代替透镜,而且还不能是普通的反射镜。普通打磨镜面的反射率还不够,所以他们必须使用布拉格反射器(Bragg reflector,一种多层镜面,可以将很多小的反射集中成一个单一而强大的反射)。
《诗经》里有一句话:“溯洄从之,道阻且长。”对于如今的半导体制造业和光刻技术来说,这句话同样适用。新材料的涌现、新设计的采用注定不会停止,这是我们保持乐观的理由。

【关于转载】:转载仅限全文转载并完整保留文章标题及内容,不得删改、添加内容绕开原创保护,且文章开头必须注明:转自“半导体行业观察icbank”微信公众号。谢谢合作!
 【关于投稿】:欢迎半导体精英投稿,一经录用将署名刊登,红包重谢!来稿邮件请在标题标明“投稿”,并在稿件中注明姓名、电话、单位和职务。欢迎添加我的个人微信号MooreRen001或发邮件到 jyzhang@moore.ren
【关于投稿】:欢迎半导体精英投稿,一经录用将署名刊登,红包重谢!来稿邮件请在标题标明“投稿”,并在稿件中注明姓名、电话、单位和职务。欢迎添加我的个人微信号MooreRen001或发邮件到 jyzhang@moore.ren










