随着移动消费型电子产品对于小型化,功能集成以及大存储空间的要求的进一步提升,元器件的小型化高密度封装形式也越来越多,如多模块封装(MCM),系统封装(SiP),倒装晶片等应用得越来越多。而元件堆叠装配(PoP, Package on Package)技术的出现更加模糊了一级封装与二级装配之间的界线,在大大提高逻辑运算功能和存储空间的同时,也为终端用户提供了自由选择器件组合的可能,生产成本也得以更有效的控制。
元件堆叠装配(PoP, Package on Package), 在底部元器件上面再放置元器件,逻辑+存储通常为2到4层,存储型PoP可达8层。外形高度会稍微高些,但是装配前各个器件可以单独测试,保障了更高的良品率,总的堆叠装配成本可降至最低。器件的组合可以由终端使用者自由选择, 对于3G移动电话,数码像机等这是优选装配方案。
此文章,根据以往发表的文章,把这些文章进行整合成一份文件,方便大家查找,文章内容包括如下几部分:
-
通过DOE试验评估POP在SMT生产的各个环节制程工艺,根据评估结果以制订出标准作业工艺方法与参数,具体内容如下:

-
此篇文章通过DOE验证,找出最佳参数,并进行较大批量之PoP零件组装制程参数及焊点可靠性分析,提供未来量产PoP制程之参考依据;

-
通过此试验:检验PoP BGA焊点是否发生锡裂问题,及其验证组装制程后的生产工艺是否可靠?

-
PoP在制造工艺当中,有一个工艺难点就是PoP元件的维修,如果只有某一层出现焊接问题,要如何进行维修,且在维修过程中又不影响其他层的焊接,在这种背景下,我们针对PoP元件維修製程與治具設計进行了实验探讨。
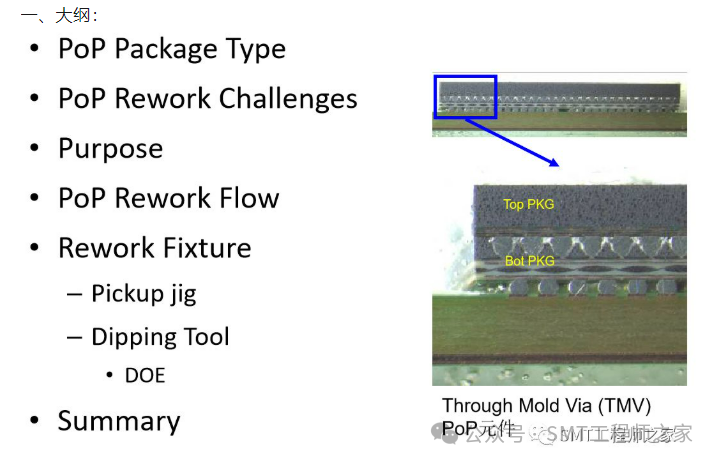
感谢大家的支持与阅读,同时希望大家多多转发,转发给更多有需要的人!
