在5G、AI、IoT以及数据中心驱动下,以智能手机为代表的“端”应用产品集成的功能越来越多,性能越来越强大,但对终端产品机身的要求却越来越小、越来越轻薄。在更小的物理空间上实现功能与性能的迭代升级,这必然需要更先进的芯片封测工艺作为支持。

佰维存储展台
在3月17-19日举办的2021 SEMICON CHINA展上,佰维BIWIN以“特色先进封测,赋能生态共赢”为主题亮相,向客户展示eMMC、ePOP、BGA SSD等得到封测工艺加持的半导体存储器产品,以及以SiP为核心的芯片封装解决方案,吸引了众多半导体存储器和芯片封测客户来访参观与洽谈。
SiP系统级封装,引领行业趋势
集成化与微型化是封装技术的两大发展趋势。SiP系统级封装是集成化方向的典型,它是将多种功能晶圆,包括处理器、存储器等根据应用场景、封装基板层数等因素,集成在一个封装内,从而实现一个基本完整功能的封装方案。而微型化是指单个芯片封装小型化、轻薄化、高I/O数发展。佰维同时在集成化与微型化两个方向上进行探索,积累了丰富的先进工艺。
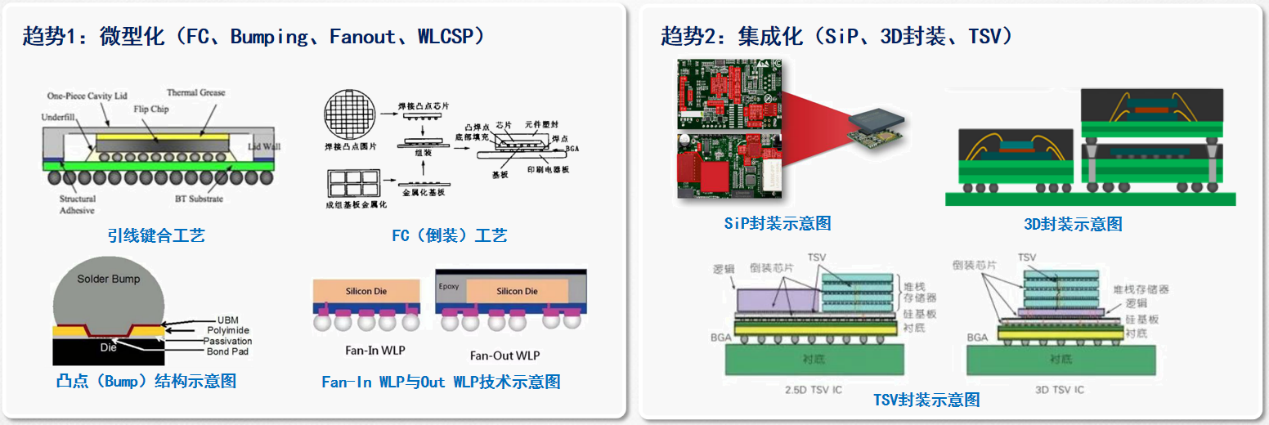
集成化与微型化技术工艺
半导体存储器以其三维堆叠结构的显著特征天然适合于系统级封装方向。佰维存储率先突破了多器件、多维度封测的技术难题,推出了一系列基于SiP封测的小型化模块产品,既做到了功能与尺寸的统一,也实现了更多的技术特点。其中,无线充电接收模块尺寸小、防水防尘,易组装;智能腕带模组集成了蓝牙模组与3轴加速度传感器,功耗低,典型适用于智能手表、智能手环等小型化智能穿戴设备;WIFI模块广泛应用于智能家居和物联网。

佰维现场
与传统SOC相比,佰维SiP封装的集成方式具有更大的设计自由度,可以有效缩短芯片开发周期,大幅降低开发费用。可以预见,佰维存储SiP封装在射频芯片、人工智能、物联网、移动智能终端等领域将大放异彩。
封装工艺与服务,赋能“端”应用存储
佰维专注存储领域十余载,开创了从产品选型、可行性评估、定制化设计开发到封测制造的一站式IC服务。其中,封测制造虽然处于存储芯片产业环节的中下游,在方案中同样拥有不可替代的价值,尤其是针对有特殊尺寸需求的应用场景,先进的封装工艺便是最优解。

存储器发展论坛现场
佰维先进封装工艺既为“端”应用产品的定制化方案提供了支持,也为佰维自身存储芯片的创新打开了通道。基于现有条件的优化组合亦是创新的形式之一。定制化存储产品并不是孤立存在,佰维综合定制化产品之间的共性,并辅以一定范围内的技术突破,持续推出存储新产品。比如成功推出的ePOP存储芯片,该产品比传统方案减小约60%的面积,厚度仅为0.9毫米,完全能让ePOP存储芯片叠堆在CPU之上。佰维新近推出的NM卡,尺寸与Nano SIM卡相同,也正是基于16层叠Die封装量产工艺。










