-
QFN 簡介:
QFN(Quad Flat No-lead Package)是一种无引脚封装,呈方形或矩形,封装底部中央位 置有一个大面积裸露的焊盘,具有导热的作用,在大焊盘的封装外围有实现电气边接导电焊 盘。其内部引脚与焊盘之间的导电路径短,自感系数以及封装体内布线电阻很低,所以,它 能提供卓越的电性能。此外,它还能过外露的引线框架焊盘提供了出色的散热性能,该焊盘 具有直接散热的通道,用于释放封装内的热量;是一种焊盘尺寸小、体积小、以塑料作为密 封材料的新兴的表面贴装芯片封装技术。 QFN 通常散热焊盘焊接在电路板上,并且 PCB 中 的散热过孔有助于将多余的功耗散到铜接地板中,从而吸收多余的热量。图 1 所示是这种采 用 PCB 焊接的外露散热焊盘的 QFN 封装。由于体积小、重量轻,加上杰出的电性能和热性 能,这种封装特别适合任何一个对尺寸、重量和性能都有高要求的应用。
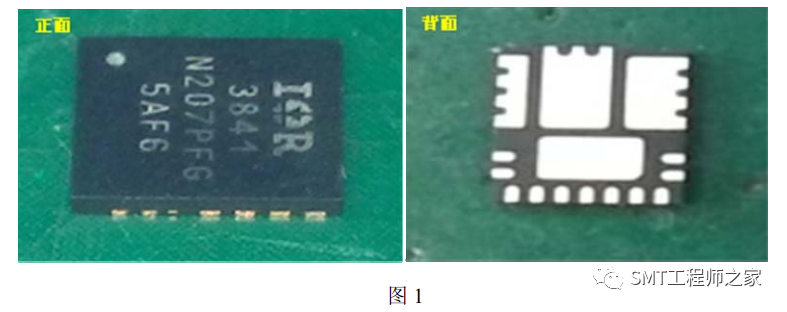
-
QFN 的焊接难点
针对无引脚底部有较大散热焊盘的 QFN 元件的焊接,无论是设备的贴附参数还是 Stencil 的厚度及回流参数的设定都有着巨大的挑战;对于大功率的 PWM 控制 QFN 元件其 Gnd 焊 盘的焊接性需要达到客户的需求标准对于 Stencil 的开孔方式及厚度、锡膏的颗料规格存在 微妙的关系。目前大功率的 PWM 控制 QFN 元件所面临的焊锡难点就是小 pitch 无引脚 PAD 的焊接连锡问题、较大散热焊盘虚焊、少锡及溢锡不良。 -
案例解析: 1)Stencil 的开孔形状及厚度的选择决定了产品的良率及可靠性。下面从我司遇到的案例进 行介绍,以某服务器电源产品 IR3841MTRPbF QFN package 为例:失效模式:该产品设计的设计为 Vin,SW,PGnd 散热焊盘,要求散热性及导电性良好,在 Reflow 制程中存在 Vin,SW,PGnd 散热焊盘溢锡导致短路不良。 2)为了控索以上失效模式,我 司从 Stencil 的两个方面进行验证: 3.1 制程条件及工艺参数: 3.1.1 焊接材料为锡银铜合金 SAC387 无铅锡膏,焊锡粉规格为: Type3. 3.1.2 焊接材料印刷设备(松下 SP 28P-DH)参数:锡印速度:85mm/s,锡印压力:28N, 脱膜速度:0.3mm/s,脱膜距离:3.0mm,实测锡膏厚度范围:0.15mm~0.17mm,刮刀材质:钢 材。 3.2 方案一: 根据 IC 厂商方案以元件引脚 PAD 尺寸为开孔标准,散热焊盘外围内切 0.15mm。 1)元件基本信息:Vin,SW,PGnd 散热焊盘间距:0.25~0.30mm,如图 2: 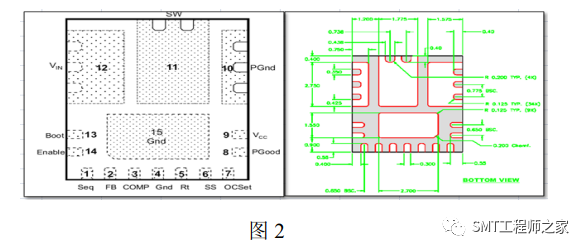
2)Stencil 的开孔与原文件对比如图 3:
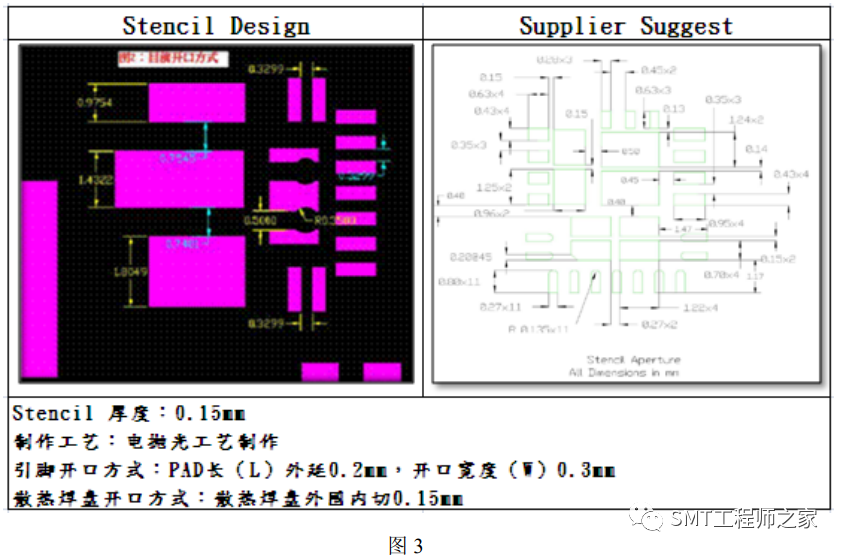
3)散热焊盘模板开孔尺寸比例在 80%以上,引脚 PAD 采用倒圆角的方式,Stencil 的开孔 面积比>0.66,宽深比>1.66 符合 IPC-7525A 标准。 4)验证结果:根据以上以 IC 厂商方案以元件引脚 PAD 尺寸为开孔标准的方案不可行,回 流后 Vin,SW,PGnd 散热焊盘存在上锡不足焊接材料覆盖面积小于 75%,引脚位置又存在溢 锡形成锡珠现象不符合客户需求。 3.3 方案二: 将 Stencil 上 SW 散热焊盘与相邻的 PAD 边内切 0.1mm,引脚 PAD 长度外延 0.15mm,其他信息与方案一一致,如图 4:
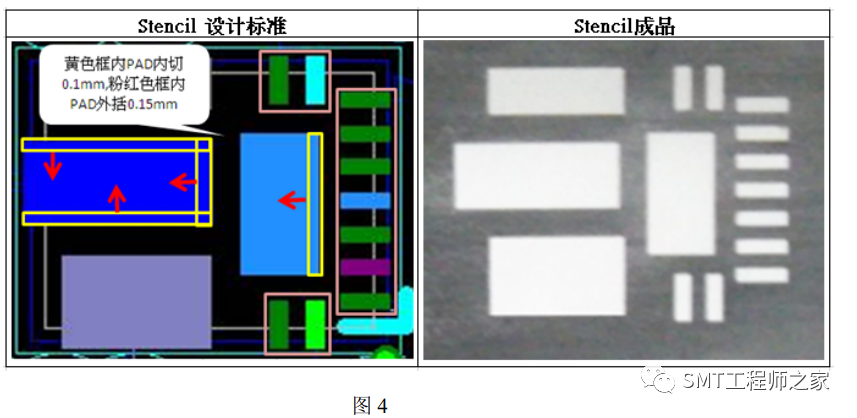
验证结果:使用方案二的开口方式其焊接品质及电性功能完全满足客户需求。
-
总结:
1)经过多次的实验验证,我公司已积累了服务器电源行业 QFN 元件焊接的部分经验。QFN 元件良好的焊接需要基于焊接材料堆积的高度及 Stencil 的开孔形状的基础上,焊接材料的 覆盖面积在80%~85%之间会形成良好的焊点,润湿面积及电性导通功能也可达到客户的需 求,也可以避免溢锡而导致短路的产生。 2)QFN 元件的外露引脚大部份都是与散热焊盘是一个整体,所以在 Stencil 开孔时网状孔一 般不建议,可按元件 PAD 尺寸开通孔,因为网状孔在回流润湿过程中引脚 PAD 上焊料会被 拉至向中间散热焊盘位置,外露引脚 PAD 会出现少锡现象。 3)QFN 元件的各散热焊盘之间 Stencil 开孔的方式需保证其安全距离在 3.5mm 以上。
SMT QFN 元器件接地失效不良分析改善案例
发布时间: 2024-10-12 07:08:02
来源: SMT工程师之家
文章来源于: SMT工程师之家
原文链接
本站所有转载文章系出于传递更多信息之目的,且明确注明来源,不希望被转载的媒体或个人可与我们联系,我们将立即进行删除处理。










