过去数十年来,为了扩增芯片的晶体管数量以推升运算效能,半导体制造技术已从1971年10,000nm制程进步至2022年3nm制程,逐渐逼近目前已知的物理极限,但随着人工智能、AIGC等相关应用高速发展,设备端对于核心芯片的效能需求将越来越高; 在制程技术提升可能遭遇瓶颈,但是运算资源需求持续走高的情况下,透过先进封装技术提升芯片之晶体管数量就显得格外重要。
本文引用地址:01
半导体先进封装技术
这两年“先进封装”被聊得很多,“封装”大概可以类比为对电子芯片的保护壳,保护电路芯片免受外界环境的不良影响。当然芯片封装还涉及到固定、散热增强,以及与外界的电气、信号互连等问题,而“先进封装”的核心还在“先进”二字上,主要是针对 7nm 以下晶圆的封装技术; 然而,人工智能浪潮下,带动AI服务器需求成长,也带动英伟达GPU图形芯片需求,而GPU的先进封装产能供不应求,那究竟什么是?
02
什么是?
CoWoS 是一种 2.5D、3D 的封装技术,可以分成“CoW”和“WoS”来看。“CoW(Chip-on-Wafer)”是芯片堆叠; “WoS(Wafer-on-Substrate)”则是将芯片堆叠在基板上。CoWoS 就是把芯片堆叠起来,再封装于基板上,最终形成 2.5D、3D 的型态,可以减少芯片的空间,同时还减少功耗和成本。下图为CoWoS封装示意图,将逻辑芯片及HBM(高带宽存储器)先连接于中介板上,透过中介板内微小金属线来整合左右不同芯片的电子讯号,同时经由“硅穿孔(TSV)”技术来连结下方基板,最终透过金属球衔接至外部电路。
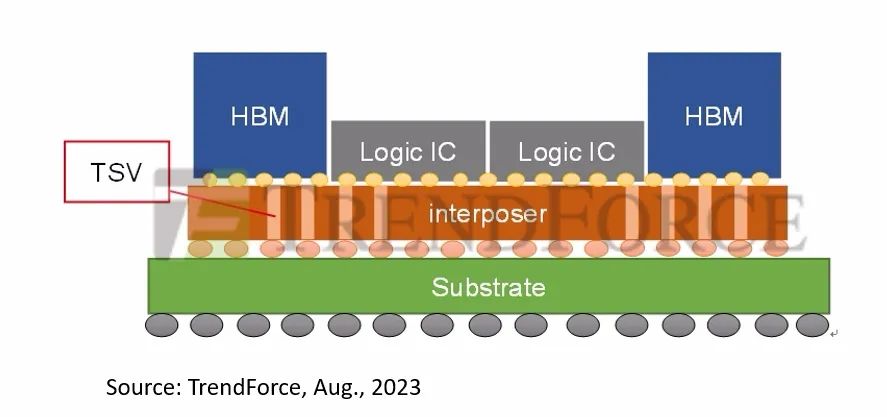
而2.5D与3D封装技术则是差别在堆叠方式。2.5D 封装是指将芯片堆叠于中间层之上或透过硅桥连结芯片,以水平堆叠的方式,主要应用于拼接逻辑运算芯片和高带宽存储器; 3D 封装则是垂直堆叠芯片的技术,主要面向高效能逻辑芯片、SoC 制造。

03
先进封装不在封装厂完成?
说到先进封装,首先想到的会是台积电而非传统封测大厂,因为先进封装已经面临到 7nm 以下,而传统封装厂研发速度已无法跟进晶圆制程的脚步,其中 CoWoS 中的 CoW 部分过于精密,只能由台积电制造,所以才会造就这番景象。同时,台积电拥有许多全世界的高端客户,为此“一条龙”的服务更能同时维持制程与封装部分的良率,未来面对高阶客户的交付工作也将更为极致。
04
CoWoS的应用发展
高端芯片走向多个小芯片、内存,堆叠成为必然发展趋势,CoWoS 封装技术应用的领域广泛,包含高效能运算 HPC、AI 人工智能、数据中心、5G、物联网、车用电子等等,可以说在未来的各大趋势,CoWoS 封装技术会扮演着相当重要的地位。
过去的芯片效能都仰赖半导体制程的改进而提升,但随着元件尺寸越来越接近物理极限,芯片微缩难度越来越高,要保持小体积、高效能的芯片设计,半导体产业不仅持续发展先进制程,同时也朝芯片架构着手改进,让芯片从原先的单层,转向多层堆叠。也因如此,先进封装也成为延续摩尔定律的关键推手之一,在半导体产业中引领浪潮。
