【导读】据businesskorea报道,SK海力士是全球首款12层HBM3产品的开发商,其目标是明年将人工智能(AI)服务器的重要组件HBM(高带宽内存)和DDR5的销量翻一番。
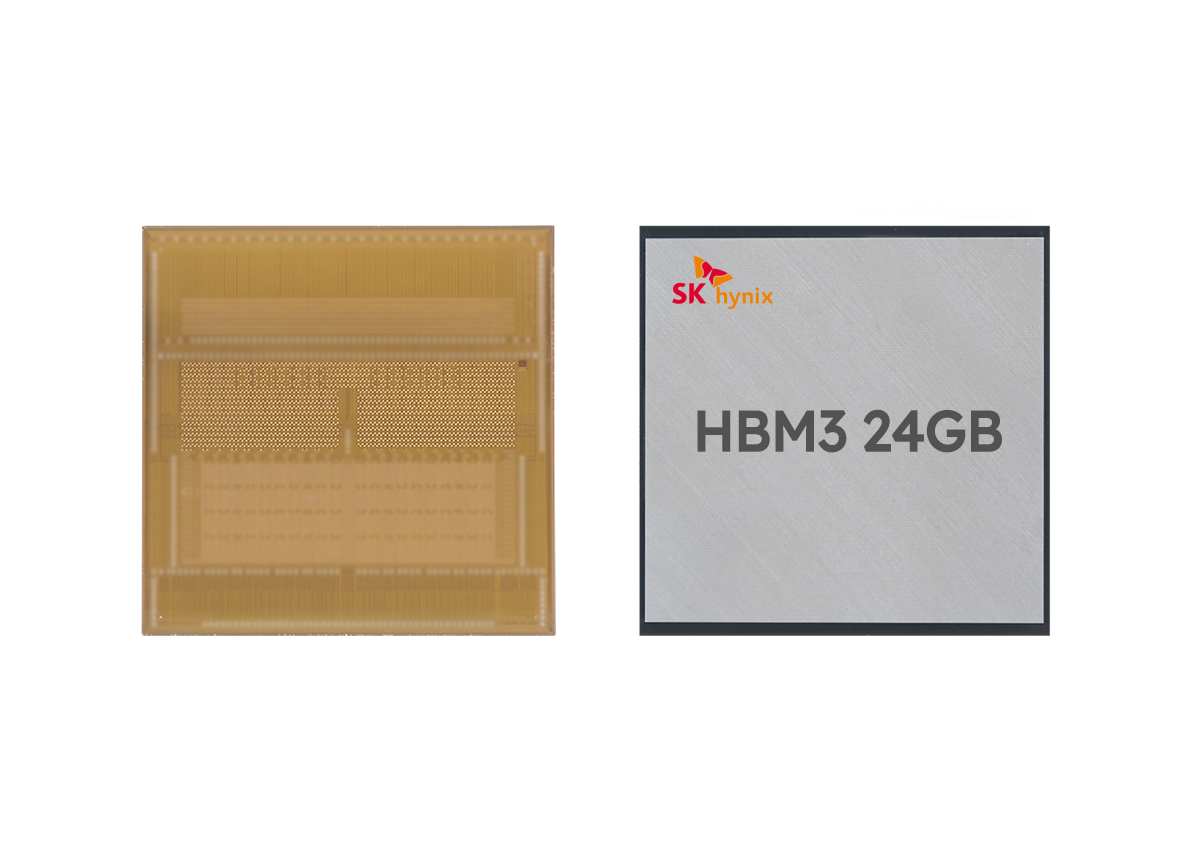
据businesskorea报道,SK海力士是全球首款12层HBM3产品的开发商,其目标是明年将人工智能(AI)服务器的重要组件HBM(高带宽内存)和DDR5的销量翻一番。
据业内消息人士7月20日透露,在最近为主要机构投资者和证券分析师举行的私人企业简报(IR)上,SK海力士预计其两条产品线的规模将在2024年增长到两倍以上。
由于人工智能需求激增,HBM和DDR5的价格和需求不断增长。垂直连接多个DRAM的高性能内存HBM比现有DRAM产品贵5至6倍。最新的DRAM标准DDR5的价格也比其前代DDR4高出15%至20%。
虽然SK海力士的HBM销售比例在数量上还不到1%,但销售额占比已增长到10%左右。如果HBM3和DDR5业务规模扩大一倍,则有望加速营收增长和利润改善。鉴于SK海力士今年上半年预计亏损超过6万亿韩元,有望通过高附加值存储器市场实现反弹。
SK海力士副总裁Park Myoung-soo对整体市场增长表示乐观,他预计AI服务器内存(包括HBM、DDR4和DDR5)在整体服务器内存市场中的份额将从今年的17%增长到五年后的38%,而AI服务器效应带来的新增DRAM需求在未来五年内将累积高达400亿GB。人工智能融入日常生活的五年之后,随着需求和使用设备的增加,DRAM市场预计将增长3至5倍。
SK海力士还透露了其下一代产品的具体路线图,将第六代HBM产品HBM4的生产目标定为2026年。目前,SK海力士已确定明年上半年为下一代产品HBM3E的量产时间。从技术上来说,SK海力士开发了旗下首个封装技术MR-MUF(Mass Reflow Molded Underfill),涉及在芯片上堆叠芯片。SK海力士公开表示,他们将把下一代后处理技术“混合键合(hybrid bonding)”应用于HBM4产品。与现有的“非导电膜”工艺相比,提高散热效率并减少布线长度,从而实现更高的输入/输出密度。这会将当前的最大12层增加到16层。
包括SK海力士在内的半导体行业围绕高附加值DRAM的技术和数量竞争预计将日益激烈。三星电子计划于今年底开始HBM3生产,并计划投资数千亿韩元,将忠南天安工厂的HBM产能提高一倍。从第四季度开始,三星的HBM3也将供应英伟达,当前由SK海力士HBM独家供货。
根据TrendForce数据,截至2022年,SK海力士占据HBM市场近50%的份额,紧随其后的是三星(约40%)和美光科技(10%)。TrendForce表示,随着更多客户采用HBM3芯片,SK海力士的市场份额将进一步提高至53%,此外三星和美光将分别占据38%和9%的份额。
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请联系小编进行处理。
推荐阅读:
