
版权声明:本文内容来自中国证券报,如您觉得不合适,请与我们联系,谢谢。
春节刚过,全球半导体并购即再添新案例。全球第二大集成电路封装测试供应商安靠(Amkor)3日宣布与NANIUM S.A.达成收购协议。安靠预计该项交易将于2017年一季度完成。
资料显示,NANIUM S.A.位于葡萄牙波尔图,是欧洲最大的半导体封装与测试外包服务商,其晶圆级芯片封装解决方案(WLCSP)世界领先,高良率、可靠的晶圆级扇出封装技术已用于大规模生产。目前,NANIUM已利用最先进的300mm晶圆级封装产线出货近10亿颗扇出封装产品。
对于本次收购,安靠董事长兼首席执行官Steve Kelly表示,“此次战略性的收购将巩固安靠作为晶圆级封装和晶圆级扇出封装领域领先供应商之一的地位。基于NANIUM成熟的技术,安靠能扩大生产规模,扩展这项技术的客户群。”
业内人士表示,此次收购将有助于增强安靠在晶圆级扇出型封装市场的地位。扇出型封装不仅具有超薄、高I/O脚数等特性,还因省略黏晶、打线等而大幅减少材料及人工成本,产品具有体积小、成本低、散热佳、电性优良、可靠性高等优势。其中,单芯片扇出封装主要用于基频处理器、电源管理、射频收发器等芯片;高密度扇出封装则主要用于处理器、记忆体等芯片。研究机构Yole认为,在苹果和台积电的引领下,扇出型封装市场潜力巨大。
为什么重视晶圆级封装?
不得不说,自从苹果在A10处理器上采用了台积电的FOWLP技术之后,大家都晶圆级封装的关注度达到了空前的高度。那么究竟什么是晶圆级封装呢?理论上,晶圆级封装由于不需要中介层(Interposer)、填充物(Underfill)与导线架,并且省略黏晶、打线等制程,因此能够大幅减少材料以及人工成本;除此之外,WLP大多采用重新分布(Redistribution)与凸块(Bumping)技术作为I/O绕线手段,因此WLP具有较小的封装尺寸与较佳电性表现的优势,目前多见于强调轻薄短小特性的可携式电子产品IC封装应用。
而根据安靠的介绍,晶圆级芯片尺寸封装(WLCSP)是一种先进的封装技术,完成凸块后,不需要使用封装基板便可直接焊接在印刷电路板上。它是受限于芯片尺寸的单一封装。更详细描述的话,它是函盖了再分布层(RDL),晶圆凸块(Bump),晶圆级测试(Test),塑封体切割(Sawing)和以载带形式的包装(Tape and Reel),支持一条龙外包服务的解决方案。
从现行量产数量来看,WLCSP是五大先进封装技术的主力之一,由于WLCSP封装时不需封装基板,在性能/成本上有非常高性价比的优势。在封装选型时,如果尺寸大小,工艺要求,布线可行性,和I/O数量都能满足需求时,最终客户有很大机会会选择WLCSP,因为它可能是成本最低的封装形式。
晶圆级封装也能适用于广泛的市场,如模拟/混合信号、无线连接、汽车电子, 也涵盖集成无源器件(IPD)、编解码器(Codec)、功率放大器(Power Amplifier)、驱动IC(Driver),射频收发器(RF Transceivers),无线局域网网络芯片(Wireless LAN)、导航系统(GPS),和汽车雷达(Automotive Radar)。WLCSP能提供最低的成本,最小的尺寸,是性价比最高,最可靠的半导体封装类型之一。从市场的角度看,非常适合但不限于手机、平板电脑、笔记本电脑、硬盘、数码摄像机、导航设备、游戏控制器及其他便携式/远程产品和汽车的应用。
从历史上看,晶圆级尺寸封装(WLCSP)已经引领在手持式电脑,平板和计算机市场,以及最近的汽车和可穿戴市场。今天,在高端智能手机中30%的封装是WLCSP。
根据Yole 数据,WLCSP市场规模预计将从2014年的$3B美元增长到2020年的 $4.5B美元,图中显示年复合增长率为8%(图1)。该市场估算已包括晶圆级,芯片级和测试等项目。此外,WLCSP制造,还是以外包封装测试服务供应商(OSAT)为主。根据Yole数据显示,排名前十的厂商中有八家来自于OSAT;其余一家是IDM(TI);另一家是晶圆制造厂商(TSMC)。

Fan-in和Fan-out的区别
从技术特点上看,晶圆级封装主要分为Fan-in和Fan-out两种。传统的WLP封装多采用Fan-in型态,应用于低接脚(Pin)数的IC。但伴随IC讯号输出接脚数目增加,对锡球间距(Ball Pitch)的要求趋于严格,加上印刷电路板(PCB)构装对于IC封装后尺寸以及讯号输出接脚位置的调整需求,因此变化衍生出扩散型(Fan-out)与Fan-in加Fan-out等各式新型WLP封装型态,其制程甚至跳脱传统WLP封装概念。
根据Amkor中国区总裁周晓阳介绍:采用Fan-in封装的芯片尺寸和产品尺寸在二维平面上是一样大的,芯片有足够的面积把所有的I/O接口都放进去。而当芯片的尺寸不足以放下所有I/O接口的时候,就需要Fan-out,当然一般的Fan-out 在面积扩展的同时也加了有源和/或无源器件以形成SIP。
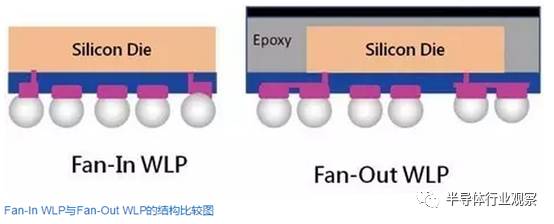
首先谈一下扇入型。
根据麦姆斯咨询的一份报告显示。扇入型封装技术已经成功获得应用,并稳定增长了十余年。由于其固有的、无可比拟的最小封装尺寸和低成本相结合的优势,至今仍极具吸引力。凭借这些优势,它逐渐渗透进入受尺寸驱动的手持设备和平板电脑市场,并在这些设备领域仍保持旺盛的生命力。据估计,目前有超过90%的扇入型封装技术应用在手机领域。谈及扇入型封装技术应用,如今高端智能手机内所有的封装器件中,超过30%采用了扇入型封装。因此,扇入型封装技术在手机领域还处于商业黄金期。
尽管扇入型封装技术的增长步伐到目前为止还很稳定,但是全球半导体市场的转变,以及未来应用不确定性因素的增长,将不可避免的影响扇入型封装技术的未来前景。随着智能手机出货量增长从2013年的35%下降至2016年的8%,预计到2020年这一数字将进一步下降至6%,智能手机市场引领的扇入型封装技术应用正日趋饱和。尽管预期的高增长并不乐观,但是智能手机仍是半导体产业发展的主要驱动力,预计2020年智能手机的出货量将达20亿部。
目前主要的扇入型封装器件为WiFi/BT(无线局域网、蓝牙)集成组件、收发器、PMIC(电源管理集成电路)和DC/DC转换器(约占总量的50%),以及包括MEMS和图像传感器在内的各种数字、模拟、混合信号器件。扇入型封装技术未来可能面临的最大挑战,或将是系统级封装的器件功能集成。下图为系统级封装增长对扇入型封装出货量的影响,其整体复合年增长率从9%下降到了6%。本报告详细分析了系统级封装的增长及其对扇入型封装的影响。

受系统级封装影响的扇入型封装出货量预测
而扇入型的市场,从2015年的统计显示,看出外包半导体封测占据了主要的市场份额,其中包括一家IDM厂商(TI,德州仪器)和一家代工厂(TSMC,台积电)。STATS ChipPAC(新科金朋)被JCET(长电科技)收购后展现出强劲的跨跃发展。而在设计端,Qualcomm(高通)和Broadcom(博通)推动了整个扇入型封装50%的市场。

扇入型封装制造市场份额
关于封装技术,过去几年市场大多关注扇出型晶圆级封装技术的发展。但是,扇入型封装走出了一条自己的发展道路和路径图,除了进一步扩展,它仍能带来其它类型的创新技术,如六面模具保护等。本报告提供了两种扇入型封装技术发展路径图的详细分析:一种为大规模批量生产(HVM)路径图,另一种为生产就绪路径图。路径图包括I/O计数器、L/S、凸点间距、封装厚度、尺寸等等。此外,本报告还从利用IC技术节点和进一步前端扩展扇入型IC器件方面分析了扇入型封装技术。尽管扇入型封装技术的HVM生产路径的扩展速度慢于扇出型封装技术,但扇入型封装技术有能力达到大多数扇出型封装的扩展条件,具备随时可提供的生产就绪发展路径。
其次谈一下扇出型;
扇出型封装采取拉线出来的方式,成本相对便宜;fan out WLP可以让多种不同裸晶,做成像WLP制程一般埋进去,等于减一层封装,假设放置多颗裸晶,等于省了多层封装,有助于降低客户成本。此时唯一会影响IC成本的因素则为裸晶大小。
2013年起,全球各主要封测厂积极扩充FOWLP产能,主要是为了满足中低价智慧型手机市场,对于成本的严苛要求。FOWLP由于不须使用载板材料,因此可节省近30%封装成本,且封装厚度也更加轻薄,有助于提升晶片商产品竞争力
麦姆斯咨询的报告显示,2016年是扇出型封装市场的转折点,苹果和台积电的加入改变了该技术的应用状况,可能将使市场开始逐渐接受扇出型封装技术。扇出型封装市场将分化发展成两种类型:
– 扇出型封装“核心”市场,包括基带、电源管理及射频收发器等单芯片应用。该市场是扇出型晶圆级封装解决方案的主要应用领域,并将保持稳定的增长趋势。
– 扇出型封装“高密度”市场,始于苹果公司APE,包括处理器、存储器等输入输出数据量更大的应用。该市场具有较大的不确定性,需要新的集成解决方案和高性能扇出型封装解决方案。但是,该市场具有很大的市场潜力。
由于扇出型封装技术具有潜力巨大的“高密度”市场和增长稳定的“核心”市场,该领域的供应链预计将在扇出型封装能力方面投入巨资。一些厂商已经能够提供扇出型晶圆级封装,但还有许多厂商仍处于扇出型封装平台的开发阶段,以期能够进入扇出型封装市场,扩大它们的产品组合。
除了台积电之外,STATS ChipPAC(新加坡星科金朋)将利用JCET(江苏长电科技)的支持进一步投入扇出型封装技术的开发(2015年初,江苏长电科技以7.8亿美元收购了新加坡星科金朋);ASE(日月光集团)则和Deca Technologies建立了深入的合作关系(2016年5月,Deca Technologies获日月光集团6000万美元投资,日月光集团则获得Deca Technologies的M系列扇出型晶圆级封装技术及工艺授权);Amkor(安靠科技)、 SPIL(矽品科技)及Powertech(力成科技)正瞄准未来的量产而处于扇出型封装技术的开发阶段。三星看上去似乎有些落后,它正在抉择如何参与竞争。
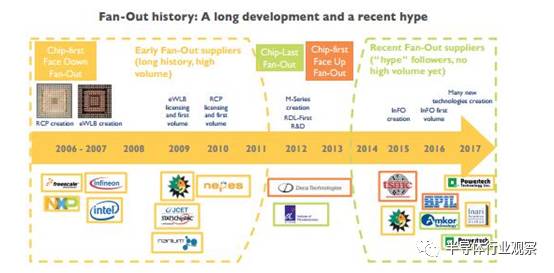
扇出型技术的发展历史
而在市场容量方面,扇出型封装保持56%的复合年增长率,未来将会给封测厂商带来广阔的前景。

扇出型封装的市场营收预测(按市场类型划分)
但这个新技术在未来还要面临很大的挑战,Amkor中国区总裁周晓阳表示,Fan-out技术在尺寸比较小、比较薄,速度比较快的应用领域,该技术会有很大的需求。目前的Fan-out成本相对较高,需要在技术上进一步优化。该技术除了wafer-based之外,还有不少厂商也在做panel-based。
目前,台积电(TSMC)也是Fan-out技术的主要推动者之一,而Amkor和其他主要封测公司也都有各自不同形式的Fan-out独门技术。相对来讲,目前的Fan-out技术还不是很成熟,其成品率和可靠性还有待于进一步提升。

【关于转载】:转载仅限全文转载并完整保留文章标题及内容,不得删改、添加内容绕开原创保护,且文章开头必须注明:转自“半导体行业观察icbank”微信公众号。谢谢合作!
 【关于投稿】:欢迎半导体精英投稿,一经录用将署名刊登,红包重谢!来稿邮件请在标题标明“投稿”,并在稿件中注明姓名、电话、单位和职务。欢迎添加我的个人微信号MooreRen001或发邮件到 jyzhang@moore.ren
【关于投稿】:欢迎半导体精英投稿,一经录用将署名刊登,红包重谢!来稿邮件请在标题标明“投稿”,并在稿件中注明姓名、电话、单位和职务。欢迎添加我的个人微信号MooreRen001或发邮件到 jyzhang@moore.ren
