2022年是晶体管诞生75周年,1947年12月,美国贝尔实验室的肖克利、巴丁和布拉顿组成的研究小组,研制出一种点接触型的锗晶体管,这是从“电子管”迈入“晶体管”时代的标志,也为后来集成电路的发明乃至整个信息产业的发展奠定了基础。
同样是在2022年,英特尔CEO宣布了一个宏伟计划,那就是到2030年,一个芯片封装上可以有1万亿个晶体管。
从一个到一万亿个,晶体管数量的增长将进一步印证摩尔定律的预言。而为了延续摩尔定律,英特尔提出了RibbonFET以及PowerVia两大突破性技术,以及High-NA光刻等,以达成这一雄伟目标。
在2022 IEDM上,英特尔继续一口气发布了8篇论文,这些由英特尔组件研究部门牵头的前沿研究,再一次印证了英特尔追求摩尔定律的决心。
英特尔研究院副总裁、英特尔中国研究院院长宋继强博士日前向公众介绍了这8篇论文,这些论文围绕着3D封装、2D材料以及新的存储产品三大方向。其中,3D封装和2D材料是英特尔下一步缩微的重点方向。

论文一览
3D封装与“准单片概念”
英特尔此次提出了“准单片(quasi-monolithic)”的概念,在这一概念下,Wafer Fab通过更多的工艺流程,从而整合出和单片没有太多差异3D封装芯片。
通过英特尔的“混合键合技术”,芯片互联间距从2021年的10微米缩小到如今的3微米,密度提升了十倍,也意味着其3D封装已经可以做到接近wafer级水平。通过提升引脚互联密度,可以有效提高信号传输带宽,并且降低面积和功耗。
和线宽制程的进展一样,3D封装也需要不断克服各项挑战。宋继强举例道,在混合键合技术中,包括触点的平整度,芯片键合的对准,键合温度以及键合填充料的多少,都需要有详细的研究、测试和验证过程。
同时,英特尔的多芯片互联工艺在材料上也进行了创新,把绝缘层过孔的有机材料替换成无机材料,无需增加额外的芯粒就可以形成过孔连接。这种TDV工艺,相比硅通孔TSV,除了具有更好的功率和信号完整性,也可以使芯粒之间可以实现更灵活的连接,而不只有垂直形式。同时,选择无机材料也可以使Wafer Fab与封装厂的工艺兼容,从而实现更好的商业化。
“混合键合技术的间距并不是一下子推进到3微米的,只能通过各种试验或组合测试,才能实现一步步的推进。”宋继强说道。
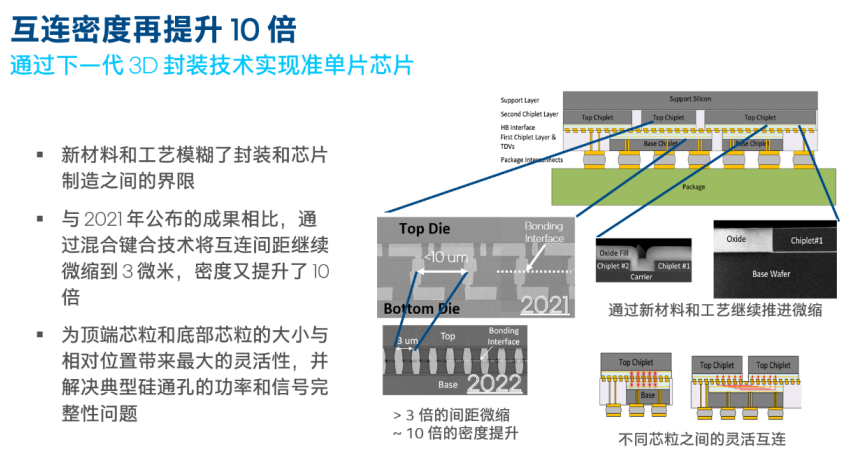
3微米间距的混合键合技术
3个原子厚的超薄二维材料
材料同样是晶体管微缩的关键。宋继强表示,英特尔采用RibbonFET结构实现GAA时,随着源极和漏极之间的间距缩小,硅材料会带来明显的短沟道效应。英特尔尝试采用了过渡金属硫化物,这种只有3个原子厚度的二维材料,导电性非常好,因此可以替代沟道上的硅。
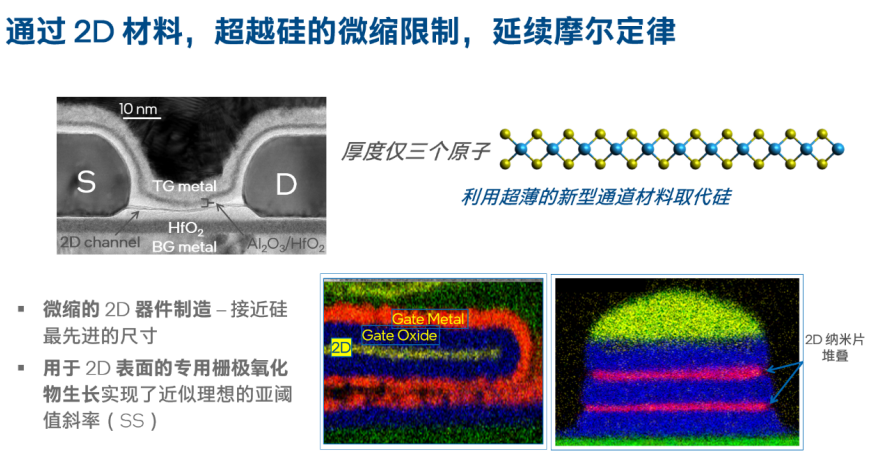
先进的过渡金属硫化物
在论文中,英特尔表示这种超薄“2D纳米片”还可以实现堆叠,也就意味着可以有更多的门控制。
同时,英特尔还验证了2D材料的不同接触模式,包括顶层接触、边缘接触以及两者兼而有之的混合接触模式。在几种不同接触模式下,英特尔都全面分析了触点的控制能力和电流,并进行完整的分析建模,这是利用新材料制备环绕栅极多层堆叠晶体管的先期准备。
其他亮点
此外,在本届IEDM上,英特尔还展现了其他方面的诸多亮点。
比如英特尔300mm硅基氮化镓的突破,其截止频率最高可达680GHz,并且FoM相比行业一般标准提升了20倍,非常适合5G多天线阵列的电源管理,以及其他大电流的电源管理应用。
在量子计算方面,英特尔继续进行量子比特制造稳定性的研究工作。在FeRAM高速嵌入式存储器上也实现了更高的密度。
大放异彩的组件团队
总而言之,英特尔组件研究团队继续在此次IEDM上大放异彩。正如英特尔技术开发事业部副总裁兼组件研究与设计总经理Gary Patton所说:“自人类发明晶体管75年来,推动摩尔定律的创新在不断满足世界指数级增长的计算需求。在IEDM 2022,英特尔展示了其前瞻性思维和具体的研究进展,有助于突破当前和未来的瓶颈,满足无限的计算需求,并使摩尔定律在未来继续保持活力。”
从2023年到2030年间晶体管数量翻10倍的目标是否过于激进?宋继强的回答是:“英特尔找到了一条协同创新之路,一方面不断发展晶体管的缩微技术,另外则是不断创新3D封装技术的研究。”
从近两年英特尔在IEDM上发的论文来看,这两方面的进步都是斐然的,而接下来的商用化就需要诸位拭目以待了。










