【导读】近日,TECHCET发布了针对半导体封装材料市场的最新展望,预计2022年半导体封装材料市场总体规模约为261亿美元,到2027年将有望达到300亿美元。
鉴于整个半导体行业的发展速度放缓,2023年封装材料市场规模预计将下降约0.6%,但2023年下半年就有望复苏,2024年预计将实现5%的增长。
封装材料变化趋势
TECHCET表示,从2020年开始,封装材料经历了强劲的出货和收入增长。终端市场需求的变化,加上紧张的供应链和物流限制,使整个供应链的材料价格上涨。此外,许多材料部门在可用生产能力方面受到限制。由于受到成本上升的挤压,许多供应商限制了与产能相关的投资。供应链和物流限制了供应商扩大产能的速度。

封装材料价格上涨的趋势完全扭转了十多年来的降价趋势,这在很大程度上是由于设备制造商和封装代工厂的压力。“降低成本”成为限制材料供应商产能投资的口头禅。这些需求驱动的价格上涨推动了2020年封装材料收入增长超过15%,2021增长超过20%。只要原材料和能源成本继续维持在高位,供应商在产能扩张计划中保持谨慎,目前的价格预计将保持不变。
此外,晶圆级封装、倒装芯片封装和包括系统级集成在内的异构集成,是新材料领域发展的主要驱动力。对于晶圆级封装,最大的应用仍然是移动电子,包括汽车领域在内的其他应用场景也在快速增长。倒装芯片互连在高性能计算、高频通信和其他应用中的增长仍然强劲,铜柱互连技术的使用越来越多。
常见芯片封装类型
1、DIP直插式封装
DIP是指采用双列直插形式封装的集成电路芯片,这种芯片封装已经有很多年的历史,如51单片机、AC-DC控制器、光耦运放等都在使用这种封装类型。采用DIP封装的CPU芯片有两排引脚,可以通过专用底座进行使用,当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接,对于插在底座上使用,可以易于更换,焊接难度也很低,只需要电烙铁便可以进行焊接装配。
2、LQFP/TQFP封装
PQFP/TQFP封装的芯片四周均有引脚,引脚之间距离很小、管脚很细,用这种形式封装的芯片可通过回流焊进行焊接,焊盘为单面焊盘,不需要打过孔,在焊接上相对DIP封装的难度较大。目前许多单片机和集成芯片都在使用这种封装,由于此封装自带突出引脚,在运输焊接过程中需要小心,防止引脚弯曲或损坏。
3、LGA封装
LGA封装为底部方形焊盘,区别于QFN封装,在芯片侧面没有焊点,焊盘均在底部。这种封装对焊接要求相对较高,对于芯片封装的设计也有很高的要求,否则批量生产很容易造成虚焊以及短路的情况,在小体积、高级程度的应用场景中这种封装的使用较多。
4、BGA(球栅阵列)封装
随着集成技术的进步、设备的改进和深亚微米技术的使用,LSI、VLSI、ULSI相继出现,硅单芯片集成度不断提高,对集成电路封装要求更加严格,I/O引脚数急剧增加,功耗也随之增大。BGA封装是一种电子元件封装技术,它是指将电子元件封装在一个多层、由金属和陶瓷组成的球形结构中,以提供更好的热传导性能和更小的封装尺寸。BGA封装可以提供更多的连接点,比普通的插件封装多出几倍,因此可以提供更高的信号完整性和更低的电阻。BGA封装还可以提供更高的功率密度,以及更低的电磁干扰(EMI)。
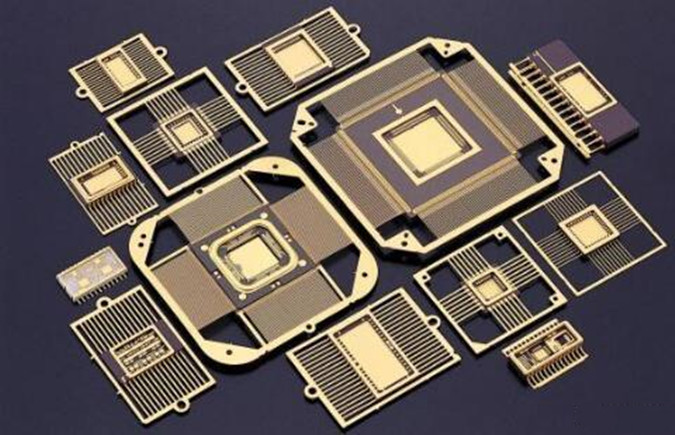
5、QFN封装类型
QFN是一种无引线四方扁平封装,是具有外设终端垫以及一个用于机械和热量完整性暴露的芯片垫的无铅封装。在芯片底部大多数会设计一块较大的地平面,对于功率型IC,该平面会很好的解决散热问题,通过PCB的铜皮设计,可以将热量更快的传导出去,该封装可为正方形或长方形。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度比QFP 低,为目前比较流行的封装类型。
6、SO类型封装
SO类型封装有很多种类,可以分为:SOP(小外形封装)、TOSP(薄小外形封装)、SSOP (缩小型SOP)、VSOP(甚小外形封装)、SOIC(小外形集成电路封装)等类似于QFP形式的封装,只有两边有管脚的芯片封装形式,该类型的封装是表面贴装型封装之一,引脚从封装两侧引出呈“ L” 字形。该类型封装的典型特点就是在封装芯片的周围做出很多引脚,封装操作方便、可靠性比较高、焊接也比较方便,如常见的SOP-8等封装在各种类型的芯片中被大量使用。
全球巨头投身先进封装
近年来,行业龙头在先进封装上投入了切切实实的真金白银,先进封装的热度不断攀升。
2022年3月,英特尔、台积电、三星和日月光等十大巨头宣布成立通用芯片互连标准——UCIe,将Chiplet(芯粒、小芯片)技术标准化。这一标准同样提供了“先进封装”级的规范,涵盖了EMIB和InFO等所有基于高密度硅桥的技术。
2022年3月,苹果发布了M1 Ultra芯片,有业内人士认为,该芯片采用了台积电的CoWoS-S(chip-on-wafer-on substrate with silicon interposer)封装工艺。
2022年12月,三星电子成立了先进封装(AVP)部门,负责封装技术和产品开发,目标是用先进的封装技术超越半导体的极限。而根据韩媒BusinessKorea报导,“三星AVP业务副总裁暨团队负责人Kang Moon-soo指出,三星将藉由AVP业务团队,创造现在世界上不存在的产品。”
报导指出,“最先进的封装技术可藉由水平和垂直的方式,连接多个异质整合技术的半导体,使更多的电晶体能够整合到更小的半导体封装中,这方式提供了超越原有性能的强大功能。”
Kang Moon-soo强调,“三星将专注于开发基于再分布层(RDL)、硅中介层/桥和硅通孔(TSV)堆叠技术的下一代2.5D和3D先进封装解决方案。”
3月9日消息,据韩国媒体BusinessKorea报导,三星为发展先进封装技术,已挖来台积电前研发副处长林俊成,担任半导体部门先进封装事业副总裁。
在当前的国际地缘及行业发展环境下,中国企业研发尖端芯片以及高性能服务器等设备的空间正变得日益逼仄。从去年10月份起,美国对中国的芯片产业进行了新一轮的全面打压。按照当时禁令,其对18纳米以下DRAM内存的生产设备、128层以上NAND闪存生产设备,以及14纳米以下逻辑芯片的生产设备全部禁售。
显然,美国欲借此阻碍中国科技发展,延续卡脖子。在此背景下,国内芯片企业生存情况不容乐观。根据统计信息,2022年国内注销、吊销的芯片相关企业数量高达5746家,比2021年数量增长了68%。
到了今年,情况进一步恶化。2月28日,美国商务部发布一系列文件,启动《芯片与科学法案》有关390亿美元芯片补贴的申请程序,意味着主要为了限制中国芯片产业发展的“芯片禁令”开始实施。
中国工程院院士、中国科学院计算技术研究所研究员倪光南曾公开表示:“我们要放弃幻想,核心技术是要不来、买不来,讨不来的”。只有我们自主研发,掌握核心技术,才能不受制于人,实现国产芯片崛起的梦想。其中,先进封装是国内半导体产业突破封锁的重要方式,因为芯片封装技术是提升芯片性能的好帮手,可以真正做到“1+1>2”的效果。
行业前景
1.以5G手机为代表的5G技术正打开全新封装市场蓝海
据Yole数据,2020年全球5G智能手机封测市场规模达5.1亿美元,预计2026年全球5G智能手机封测市场规模将达到26亿美元,21-26年CAGR将达31%。除5G智能手机的应用场景外,5G技术在物联网、智能驾驶等应用场景中也大有可为。以智能手机为代表的5G技术将成为封装市场尤其是先进封装市场最主要的助推器,在中国大陆5G手机渗透、5G技术应用推广领先全球的时代背景下,中国大陆封测厂商将迎来机遇。
2.汽车电子封装蓄势待发,增量市场规模较大
由于智能汽车需要实现自动驾驶、智能网联等功能,其需要的电子元件数目大幅增加,车载芯片封装需求预计也将大幅提升。随着先进封装工艺的不断成熟,其集成化、高算力等优势使得先进封装仍为车载芯片封装未来趋势。据Yole数据,汽车电子封装市场将从2018年的51.14亿美元增长至2024年的89.88亿美元,19-24年CAGR将达10%,其中先进封装占比将从2018年的3%提升至2024年的6%。在国内智能汽车渗透率持续提升的背景下,汽车电子将成为封装行业的重要助推剂。
3.智能可穿戴设备及HPC放量在即,助力先进封装市场规模增长
据IDC,全球服装类智能可穿戴设备出货量预计从2018年的280万台增长至2022年的910万台,由于智能可穿戴设备对微型化、集成化的需求强烈,多采用系统级封装(SiP),故智能可穿戴设备的放量将助推先进封装市场的发展。
据Gartner,全球公有云服务市场规模将从2019年的2427亿美元增至2022年的3640亿美元,公有云服务带动的HPC需求放量也将进一步驱动3D堆叠、倒装封装等先进封装市场的发展。
来源:贤集网
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请联系小编进行处理。
推荐阅读:







 技术咨询
技术咨询 代买器件
代买器件 商务客服
商务客服 研发客服
研发客服