晶圆大厂抢抓12英寸主流,半导体设备跟随布局
【导读】消费电子市场低迷环境下,半导体产业进入调整周期,不过,这不影响晶圆代工厂商的扩产步伐与全球布局。近期,又一座12英寸晶圆厂传出新动态。
晶圆代工瞄准12英寸
近期,日媒报道,世界先进即将决定赴新加坡兴建其首座12英寸晶圆厂,该工厂主要为满足车用芯片需求,投资金额至少达20亿美元。
资料显示,世界先进拥有5座8英寸晶圆厂,其中4座位于中国台湾,1座位于新加坡,今年产能估计达335万片8英寸晶圆/年。
此前,世界先进董事长方略表示,公司正在考虑在中国台湾或新加坡建造一座新的12英寸工厂,但没有具体说明该决定的时间表。今年8月,媒体报道显示,台积电同意投资世界先进计划在新加坡设立的一家12英寸晶圆厂。报道称,这家新加坡工厂将生产28纳米芯片,最早可能在2026年完工。
对此,业界认为一旦世界先进前往新加坡设立12英寸工厂,这意味着台积电、联电、力积电、世界先进等四大晶圆代工厂商都将具备12英寸厂产能,且在海外都有12英寸厂建厂计划。其中,台积电遍及美国、日本等地,联电与世界先进同为新加坡,力积电则规划在日本与合作伙伴于当地建厂。
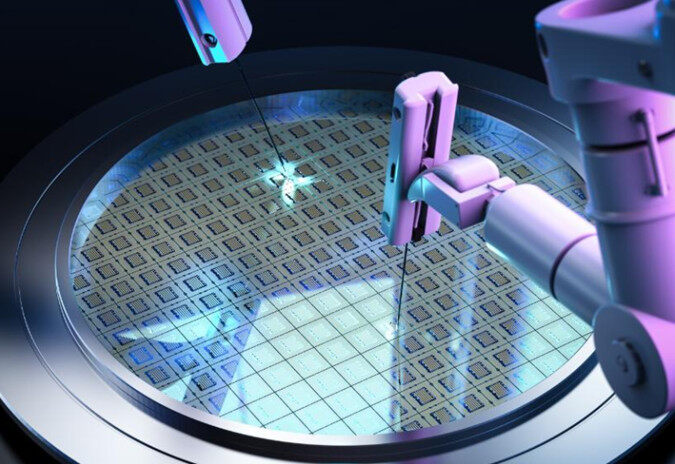
12英寸SOI晶圆成功实现国产
据中国科学院上海微系统所官微消息,上海微系统所魏星研究员团队在300mm SOI晶圆制造技术方面取得突破性进展,制备出了国内第一片300mm 射频(RF)SOI晶圆。
很多人在问300mm的晶圆到底是多大?其实就是我们常说的12英寸,文中指的是一种专门做无线收发的半导体材料。
其实,SOI(全称为绝缘硅)晶圆,这种基材不光用于射频芯片,它还可以用于功率器件、汽车电子芯片、传感器等。
而这一次,上海微系统所主要是攻克了射频晶圆工艺上的一些技术难题,即依次解决了300 mm RF-SOI晶圆所需的低氧高阻晶体制备、低应力高电阻率多晶硅薄膜沉积、非接触式平坦化等诸多核心技术难题。
据了解,RF-SOI(射频绝缘体上硅)相较于传统的GaAs和SOS技术,不仅成本更低、集成度更高,还能发挥SOI材料结构优势,所生产的器件具有高品质、低损耗、低噪声等优势,主要用于制造智能手机和无线通信设备的前端射频模块。
众所周知,射频芯片虽然原理并不复杂,但制造难度却不低,甚至成为了我国通信领域卡脖子技术,其中就包括RF-SOI晶圆基础材料。
从市场格局来看,300mm的SOI硅片核心技术主要由法国Soitec半导体公司掌握,只有日本信越化学、SUMCO、中国台湾环球晶圆等少数企业具备生产能力。
而我们国内,沪硅产业子公司在获得Soitec公司技术授权后,也于2022年完成50亿定增,其中20亿用于SOI高端基材研发,建成后预计年产能将达到40万片/年。
这一次中国科学院上海微系统所从底层技术上进行攻关,成功实现了国内300mm SOI制造技术,标志着我国已经打破了从无到有的重大局面,今后咱们也可以用上自己的高标准RF-SOI晶圆了。
核心部件100%国产化!
国内一家半导体公司制造出了第一台核心部件 100% 国产化的高端晶圆激光切割设备。
晶圆切割就是将硅晶圆切割成单个芯片的过程,因为晶圆上刻好的电路非常精密,所以在切割的过程中需要极高的精度,也就是说晶圆切割工艺对设备的要求极高。
我们可以简单地从芯片制造的过程来体会晶圆切割的在其中的角色。
上游材料厂从最开始的晶体硅锭加工到晶圆片,然后通过抛光等步骤将晶圆厂需要的晶圆材料准备好。
收到晶圆片后代工厂还需经过湿洗等步骤完成光刻准备工作,先通过光刻机在晶圆上打印特定的电路图,然后通过离子注入改变其导电特性,接下来就是蚀刻电镀等步骤完成加工,最后将晶圆表面清理干净并对其做电气测试和性能分类。
上述一切就绪后就到晶圆切割了,分离出单个芯片,然后就将分离出来的单个芯片进行封装。
晶圆切割有机械锯切、激光切割、晶圆划片以及等离子切割等,本次国内的这台 100% 核心部件国产化的晶圆切割设备就是激光切割。
据悉,该设备是由华工科技激光半导体产品黄伟团队制造出来的,并在半导体激光设备领域攻克多项中国第一。
来源:贤集网
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请联系小编进行处理。
推荐阅读:
本站所有转载文章系出于传递更多信息之目的,且明确注明来源,不希望被转载的媒体或个人可与我们联系,我们将立即进行删除处理。